基于LFSR優化的BIST低功耗設計
隨著便攜式設備和無線通訊系統在現實生活中越來越廣泛的使用,可測性設計(DFT)的功耗問題引起了VLSI設計者越來越多的關注。因為在測試模式下電路的功耗要遠遠高于正常模式,必將帶來如電池壽命、芯片封裝、可靠性等一系列問題。隨著集成電路的發展,內建自測試(BIST)因為具備了諸多優越性能(如降低測試對自動測試設備在性能和成本上的要求、可以進行At―speed測試及有助于保IP核的知識產權等),已成為解決SoC測試問題的首選可測性設計手段。
在BIST中常用線性反饋移位寄存器(LFSR)作為測試模式生成器(TPG)。LFSR必須產生很長的測試矢量集才能滿足故障覆蓋率的要求,但這些矢量消耗了大量的功率。
另外,在系統工作模式下,應用于給定電路的連續功能輸入矢量具有重要的相關性,而由LFSR產生的連續測試模式之間的相關性很低。因此,在自測試期間會增加電路中節點的翻轉活動,導致功耗增大。
2 功耗分析和WSA模型
CMOS電路中功耗的來源主要分為靜態功耗和動態功耗兩種。漏電流或從電源供給中持續流出的其它電流導致靜態功耗。動態功耗則是因為短路電流和負載電容的充放電,從而由電路正常工作時的功能跳變所引起的,它包括功能跳變、短路電流、競爭冒險等。對于CMOS工藝來說,目前動態功耗是電路功耗的主要來源。
對于節點i上每次開關上的功耗為:
![]()
式中,Si是單周期內翻轉的次數,Fi是節點i的扇出,C0是最小輸出負載電容,VDD是電源電壓。
從式(1)看出,門級的功耗估計與Si和Fi的乘積和節點i的翻轉次數有關。節點的扇出由電路拓撲決定,而它的翻轉次數由邏輯模擬器來估計。這個乘積即稱為節點i的權重翻轉活動(Weighted Switching Activity,WSA)。在測試過程中WSA是節點i功耗Ei的唯一變量,所以WSA可作為該節點的功耗估計。對于一對連續的輸入矢量TPk=(Vk-1,Vk),電路總的WSA為:

式中i是電路中所有節點的個數,S(i,k)是由TPk所激勵節點i的翻轉次數。
根據式(2),考慮長度為L的測試矢量TS作為電路的輸入矢量,電路總的WSA為:

根據以上功率和能量消耗的表達式,再給定一個電路設計為CMOS的工藝和供給電源,可得以下結論:
(1)電路中節點i的跳變數成為唯一的影響能量、最大功耗和平均功耗的參數。
(2)測試中時鐘的頻率也影響著平均功耗和最大功耗。
(3)測試長度,即施加在待測電路(CUT)上的測試向量的數目一只影響總的能量的消耗。
3 LFSR優化的低功耗方法
通過對測試過程的功耗分析可知,選擇BIST低功耗的方案時,一方面可以通過減少測試序列長度來實現(但該方法往往以犧牲故障覆蓋率為代價),另一方面降低WSA值也可實現系統功耗的降低。
在BIST結構中,線性反饋移位寄存器(LFSR)由于結構的簡單性、規則性、非常好的隨機測試矢量生成特性、用來壓縮測試響應時的混淆概率非常小等特點,在DFT的掃描環境中很容易集成,所以當從掃描DFT設計升級成BIST設計時,LFSR因其硬件開銷很小而成為BIST中應用最廣的矢量生成結構。
基于LFSR優化的BIST結構可分為test―per-一scan和test―per―clock兩類結構。test―per―scan技術引起的面積開銷較小,測試結構簡單,易于擴展:而test―per―clock在一個周期內可實現矢量的生成和響應壓縮,能夠完成快速的測試。
3.1 基于掃描的test―per―scan方式
3.1.1 基本結構
test―per一scan內建自測試的目標是盡可能的降低硬件開銷。這種結構在每個輸入輸出端口處使用LFSR與寄存器的組合來代替LFSR。圖l是test―per-scan內建自測試的基本電路結構。在內建自測試矢量下,LFSR生成測試矢量并且通過掃描移位寄存器(shift register)將測試矢量移位到待測電路(CUT)的輸入端,同時響應被移入LFSR并壓縮。

3.1.2 原理
全掃描或部分掃描設計中由于移位會產生比較大的功耗。基于掃描的test一per-scan低功耗設計方法需要修改標準的掃描設計,降低狀態轉換活動率。沒計修改包括在移位期間用于屏蔽掃描路徑活動的一些門控邏輯,以及對用于抑制隨機模式的附加邏輯進行綜合等。
3.1. 3 部分掃描算法
根據以上掃描設計原理,在消除測試序列中的冗余模式之后,采用圖2所示的部分掃描算法對待測電路進行部分掃描設計。其步驟如下:
①首先刪除所有自反饋時序邏輯對應的頂點。
②在數據流圖中查找所有的強連通單元(Strongly Connected Components,簡稱SCC)。







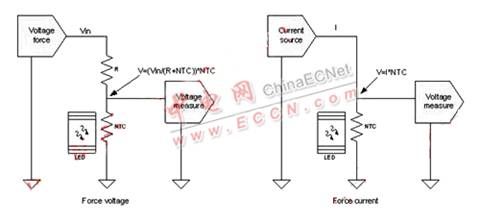

評論