FCOS技術被引入智能卡制造
——
FCOS技術被引入智能卡制造
FCOS (Flip Chip on Substrate板上倒裝芯片)技術是英飛凌科技公司(Infineon)與捷德(Giesecke&Devrient)公司聯合研制開發的一種專用于IC卡應用的創新芯片封裝工藝。它融合了最新芯片倒裝工藝和革新的材料技術,首次將集成電路“倒裝”在IC卡外殼中。芯片的功能面通過傳導觸點直接連接至模塊,不再需要傳統的金線和人造樹脂等封裝材料,新型連接技術不僅節省了模塊內的空間,而且比常規接線方式更為牢固。并且也是業界首次將FOCS技術應用在智能卡生產中。
英飛凌科技公司智能卡安全業務部市場高級總監Axel Deiniger介紹說,倒裝芯片技術是指把半導體芯片與載帶相連接的工藝流程。這個流程包括把芯片倒裝使它的電路接觸凸點面向載帶。電路接觸凸點是由傳導材料制成的,即在芯片電路面載體之間的“凸點”。芯片和載帶是由一種非導電性粘膠機械地粘合在一起的。
倒裝芯片技術可增加載帶上器件的密度,并且相對于現行的金線鍵合技術通過金線電連接方式,它是一種更加直接、穩定的電連接方式。因此不再需要包封膠來保護芯片的接觸部分了。英飛凌認為,公司開發和革新的倒裝芯片封裝工藝,即FCOS技術非常適用于接觸式智能卡的存儲器和控制器芯片封裝。并將會在更加復雜以及高端市場得到廣泛的應用。 現在,改良的封裝密度使人們可以在只有6個觸點的模塊上封裝控制器,而不必再使用8個接觸腳的金線鍵合模塊。借助這種新工藝,還可以更快速地在IC卡中添加更多功能。而且研制芯片時,也不再需要花時間進行成本高昂的空間優化工作。所以非常適用于新型第3代SIM卡、超薄移動電話、手持讀卡器和電子支付、移動通信、身份證以及其他終端設備的應用。
Axel Deiniger說,英飛凌FCOS技術優勢體現在,通過改善模塊的平整度,改善視覺效果;擴大了植卡區域;具有更強的防腐蝕性能,尤其能適應非常潮濕的環境;并且有很好的韌性適應高動態彎曲受壓條件;由于模塊厚度可減少一半(大約300mm~500mm),非常適用于新型第3代SIM卡標準;能夠封裝面積為30mm2的芯片,可增加產量,減少生產步驟和提高交貨的速度;封裝一個6個接觸器的FCOS模塊相當于封裝一個8個接觸腳的金線鍵合模塊;由于采用了非鹵素材料,對環境沒有損害;可為客戶在工藝和使用材料方面帶來總體成本效應。更重要的是, FCOS模塊技術現已可在實踐中應用,適用于接觸型智能卡的標準生產過程。新的封裝技術已經通過了實用測試,在墨西哥,捷德公司已售出7,000多萬張基于英飛凌公司提供的FCOS模塊的預付費電話卡。
英飛凌科技公司智能卡安全業務部市場高級總監Axel Deiniger介紹說,倒裝芯片技術是指把半導體芯片與載帶相連接的工藝流程。這個流程包括把芯片倒裝使它的電路接觸凸點面向載帶。電路接觸凸點是由傳導材料制成的,即在芯片電路面載體之間的“凸點”。芯片和載帶是由一種非導電性粘膠機械地粘合在一起的。
倒裝芯片技術可增加載帶上器件的密度,并且相對于現行的金線鍵合技術通過金線電連接方式,它是一種更加直接、穩定的電連接方式。因此不再需要包封膠來保護芯片的接觸部分了。英飛凌認為,公司開發和革新的倒裝芯片封裝工藝,即FCOS技術非常適用于接觸式智能卡的存儲器和控制器芯片封裝。并將會在更加復雜以及高端市場得到廣泛的應用。 現在,改良的封裝密度使人們可以在只有6個觸點的模塊上封裝控制器,而不必再使用8個接觸腳的金線鍵合模塊。借助這種新工藝,還可以更快速地在IC卡中添加更多功能。而且研制芯片時,也不再需要花時間進行成本高昂的空間優化工作。所以非常適用于新型第3代SIM卡、超薄移動電話、手持讀卡器和電子支付、移動通信、身份證以及其他終端設備的應用。
Axel Deiniger說,英飛凌FCOS技術優勢體現在,通過改善模塊的平整度,改善視覺效果;擴大了植卡區域;具有更強的防腐蝕性能,尤其能適應非常潮濕的環境;并且有很好的韌性適應高動態彎曲受壓條件;由于模塊厚度可減少一半(大約300mm~500mm),非常適用于新型第3代SIM卡標準;能夠封裝面積為30mm2的芯片,可增加產量,減少生產步驟和提高交貨的速度;封裝一個6個接觸器的FCOS模塊相當于封裝一個8個接觸腳的金線鍵合模塊;由于采用了非鹵素材料,對環境沒有損害;可為客戶在工藝和使用材料方面帶來總體成本效應。更重要的是, FCOS模塊技術現已可在實踐中應用,適用于接觸型智能卡的標準生產過程。新的封裝技術已經通過了實用測試,在墨西哥,捷德公司已售出7,000多萬張基于英飛凌公司提供的FCOS模塊的預付費電話卡。

據了解,目前英飛凌公司主要負責FCOS模塊的基礎開發工作、模塊設計和研制FCOS模塊的生產工藝,捷德公司則負責生產基于新模塊的IC卡,并進行所有必要的芯片卡質量測試,以確定其是否適于進行大批量生產。然后,兩家公司的專家共同合作,對FCOS技術進行完善,使之能夠實際用于IC卡應用。
2005年初,英飛凌公司將在德國(雷根斯堡)和中國(無錫)工廠開始大批量生產FCOS模塊。
2005年初,英飛凌公司將在德國(雷根斯堡)和中國(無錫)工廠開始大批量生產FCOS模塊。
FCOS (Flip Chip on Substrate板上倒裝芯片)技術是英飛凌科技公司(Infineon)與捷德(Giesecke&Devrient)公司聯合研制開發的一種專用于IC卡應用的創新芯片封裝工藝。它融合了最新芯片倒裝工藝和革新的材料技術,首次將集成電路“倒裝”在IC卡外殼中。芯片的功能面通過傳導觸點直接連接至模塊,不再需要傳統的金線和人造樹脂等封裝材料,新型連接技術不僅節省了模塊內的空間,而且比常規接線方式更為牢固。并且也是業界首次將FOCS技術應用在智能卡生產中。
英飛凌科技公司智能卡安全業務部市場高級總監Axel Deiniger介紹說,倒裝芯片技術是指把半導體芯片與載帶相連接的工藝流程。這個流程包括把芯片倒裝使它的電路接觸凸點面向載帶。電路接觸凸點是由傳導材料制成的,即在芯片電路面載體之間的“凸點”。芯片和載帶是由一種非導電性粘膠機械地粘合在一起的。
倒裝芯片技術可增加載帶上器件的密度,并且相對于現行的金線鍵合技術通過金線電連接方式,它是一種更加直接、穩定的電連接方式。因此不再需要包封膠來保護芯片的接觸部分了。英飛凌認為,公司開發和革新的倒裝芯片封裝工藝,即FCOS技術非常適用于接觸式智能卡的存儲器和控制器芯片封裝。并將會在更加復雜以及高端市場得到廣泛的應用。 現在,改良的封裝密度使人們可以在只有6個觸點的模塊上封裝控制器,而不必再使用8個接觸腳的金線鍵合模塊。借助這種新工藝,還可以更快速地在IC卡中添加更多功能。而且研制芯片時,也不再需要花時間進行成本高昂的空間優化工作。所以非常適用于新型第3代SIM卡、超薄移動電話、手持讀卡器和電子支付、移動通信、身份證以及其他終端設備的應用。
Axel Deiniger說,英飛凌FCOS技術優勢體現在,通過改善模塊的平整度,改善視覺效果;擴大了植卡區域;具有更強的防腐蝕性能,尤其能適應非常潮濕的環境;并且有很好的韌性適應高動態彎曲受壓條件;由于模塊厚度可減少一半(大約300mm~500mm),非常適用于新型第3代SIM卡標準;能夠封裝面積為30mm2的芯片,可增加產量,減少生產步驟和提高交貨的速度;封裝一個6個接觸器的FCOS模塊相當于封裝一個8個接觸腳的金線鍵合模塊;由于采用了非鹵素材料,對環境沒有損害;可為客戶在工藝和使用材料方面帶來總體成本效應。更重要的是, FCOS模塊技術現已可在實踐中應用,適用于接觸型智能卡的標準生產過程。新的封裝技術已經通過了實用測試,在墨西哥,捷德公司已售出7,000多萬張基于英飛凌公司提供的FCOS模塊的預付費電話卡。
英飛凌科技公司智能卡安全業務部市場高級總監Axel Deiniger介紹說,倒裝芯片技術是指把半導體芯片與載帶相連接的工藝流程。這個流程包括把芯片倒裝使它的電路接觸凸點面向載帶。電路接觸凸點是由傳導材料制成的,即在芯片電路面載體之間的“凸點”。芯片和載帶是由一種非導電性粘膠機械地粘合在一起的。
倒裝芯片技術可增加載帶上器件的密度,并且相對于現行的金線鍵合技術通過金線電連接方式,它是一種更加直接、穩定的電連接方式。因此不再需要包封膠來保護芯片的接觸部分了。英飛凌認為,公司開發和革新的倒裝芯片封裝工藝,即FCOS技術非常適用于接觸式智能卡的存儲器和控制器芯片封裝。并將會在更加復雜以及高端市場得到廣泛的應用。 現在,改良的封裝密度使人們可以在只有6個觸點的模塊上封裝控制器,而不必再使用8個接觸腳的金線鍵合模塊。借助這種新工藝,還可以更快速地在IC卡中添加更多功能。而且研制芯片時,也不再需要花時間進行成本高昂的空間優化工作。所以非常適用于新型第3代SIM卡、超薄移動電話、手持讀卡器和電子支付、移動通信、身份證以及其他終端設備的應用。
Axel Deiniger說,英飛凌FCOS技術優勢體現在,通過改善模塊的平整度,改善視覺效果;擴大了植卡區域;具有更強的防腐蝕性能,尤其能適應非常潮濕的環境;并且有很好的韌性適應高動態彎曲受壓條件;由于模塊厚度可減少一半(大約300mm~500mm),非常適用于新型第3代SIM卡標準;能夠封裝面積為30mm2的芯片,可增加產量,減少生產步驟和提高交貨的速度;封裝一個6個接觸器的FCOS模塊相當于封裝一個8個接觸腳的金線鍵合模塊;由于采用了非鹵素材料,對環境沒有損害;可為客戶在工藝和使用材料方面帶來總體成本效應。更重要的是, FCOS模塊技術現已可在實踐中應用,適用于接觸型智能卡的標準生產過程。新的封裝技術已經通過了實用測試,在墨西哥,捷德公司已售出7,000多萬張基于英飛凌公司提供的FCOS模塊的預付費電話卡。

據了解,目前英飛凌公司主要負責FCOS模塊的基礎開發工作、模塊設計和研制FCOS模塊的生產工藝,捷德公司則負責生產基于新模塊的IC卡,并進行所有必要的芯片卡質量測試,以確定其是否適于進行大批量生產。然后,兩家公司的專家共同合作,對FCOS技術進行完善,使之能夠實際用于IC卡應用。
2005年初,英飛凌公司將在德國(雷根斯堡)和中國(無錫)工廠開始大批量生產FCOS模塊。
2005年初,英飛凌公司將在德國(雷根斯堡)和中國(無錫)工廠開始大批量生產FCOS模塊。







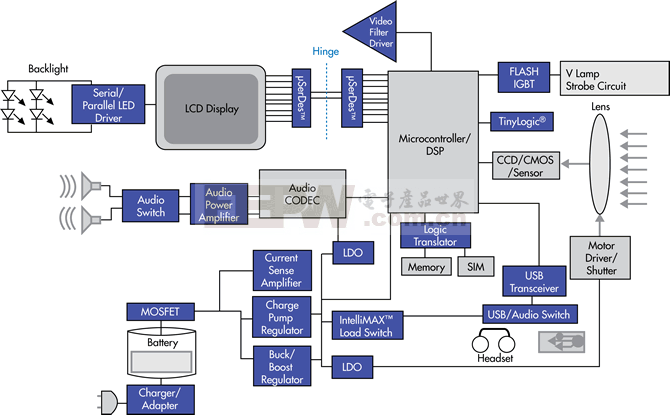





評論