KLA-Tencor 推出 5D? 圖案成型控制解決方案的關鍵系統
今天,KLA-Tencor 公司宣布推出 WaferSight™ PWG 已圖案晶圓幾何形狀測量系統、LMS IPRO6 光罩圖案位置測量系統和 K-T Analyzer® 9.0 先進數據分析系統。這三種新產品支持 KLA-Tencor 獨特的 5D™ 圖案成型控制解決方案,此方案著重于解決圖案成型工藝控制上的五個主要問題——元件結構的三維幾何尺寸、時間效率和設備效率。5D 圖案成型控制解決方案主要通過對光刻模塊工藝和非光刻模塊工藝的量化、優化和監控,來獲取最佳的圖案成型結果。通過將以上設備測量結果與智能反饋及前饋工藝控制回路相結合,此項解決方案能夠幫助芯片制造商利用現有工藝設備以更快及更有成效的方式來提升多重圖案成型技術、隔板周期分割及其他先進圖案成型技術。
本文引用地址:http://www.104case.com/article/262441.htmKLA-Tencor 參數化解決方案集團副總裁 Ahmad Khan 稱:“工藝控制為幫助我們的客戶在駕馭日漸狹窄的工藝窗口、縮小圖案疊層對準誤差預算以及復雜的創新圖案成型技術扮演了重要的角色。在光刻模塊中,我們的 Archer™ 500 疊層對準和 SpectraShape™ 9000 關鍵尺寸先進測量系統提供了識別和監測圖案成型誤差的信息。我們的新型 WaferSight PWG 和 LMS IPRO6提供了光刻模塊以外的工藝數據或光罩相關圖案位置誤差,對圖案成型偵錯提供了額外的信息。在 K-T Analyzer 9.0 靈活的數據分析支持下,它適切整合了整個晶圓廠各方面的測量數據,進而擴大了工藝窗口,因而能夠有效改善客戶尖端產品在生產線上的圖案成型監控。”
多家先進設備的集成電路制造商已在他們的研發單位或生產線安裝了 WaferSight PWG,它用于測量各個工藝階段的已圖案成型晶圓的幾何形狀,并幫助芯片制造商識別和監測其影響圖案成型的變因。WaferSight PWG 采用業界特有的垂直晶圓載座大幅度減小重力對形狀測量的影響和每晶圓 350 萬數據點的采樣密度,提供了高度精確的晶圓形狀數據,然后前饋至光刻模塊,去除晶圓幾何形狀對光刻掃描的影響,以改善圖案的疊層對準。WaferSight PWG 還采用獨特技術,可同時測量晶圓的前后表面,提供晶圓厚度指標,用來幫助減小光刻機在掃描聚焦時的誤差。WaferSight PWG 乃建構于全球晶圓制造商已經廣泛采用,用于檢測祼晶圓幾何形狀的 WaferSight 之平臺架構上。
先進的光罩制造商則使用 LMS IPRO6 做全面性光罩圖案放置誤差的鑒別,這種誤差會直接造成晶圓上的圖案疊層對準誤差。LMS IPRO6 采用基于模型的專有測量技術,除了能夠準確直接測量光罩上元件圖案的位置,它也還能測量標準型的的對準標記的位置,藉此提供有效高密度的采樣質量,以作出更可靠的光罩質量決策。LMS IPRO6 的測量時間比其前身更為快速,以支持多重圖案成型技術上需要測量更多光光罩及光罩上更多采樣點的產能需求。LMS IPRO6 能夠量取元件圖案復寫位置的誤差數據,以反饋給電子束光罩復寫器做后續改善,此位置誤差資料并能夠前饋至晶圓廠的光刻模塊,用于去除光罩誤差對光刻掃描的影響,從而改善晶圓級的圖案成型準度。
K-T Analyzer 9.0 已安裝在晶圓代工廠及內存制造廠,是最新版本的業界標準平臺,可對疊層對準、光罩位準、晶圓幾何形狀、薄膜、關鍵尺寸及元件輪廓測量系統等各種類型的測量系統進行先進的即時數據分析。K-T Analyzer 9.0 即時計算產品線上每批量光刻機上各個曝光場的個別校正,這種個別校正無需完整晶圓的測量數據,而能夠提高控制技術計算上的準確度,并進而減少圖案疊層對準誤差。此外,K-T Analyzer 9.0 新的功能還包含多臺光刻機群管理、光刻機數據分析和光刻機對準位置優化能力,為芯片制造商提供靈活的解決方案,以改善光刻機的利用率,并監控和優化光刻工藝。
WaferSight PWG、LMS IPRO6 和 K-T Analyzer 9.0 是 KLA-Tencor 的綜合 5D 圖案成型控制解決方案的組成部分,該解決方案還包括疊層對準、薄膜、關鍵尺寸和元件輪廓測量系統以及 PROLITH™ 光刻和圖案成型模擬器。為了保持高性能和高產能,滿足最先進的生產需要,WaferSight PWG、LMS IPRO6 和 K-T Analyzer 9.0 系統由 KLA-Tencor 的全球綜合服務網絡提供支持。關于更多信息,請參閱 5D 圖案成型控制解決方案網頁。






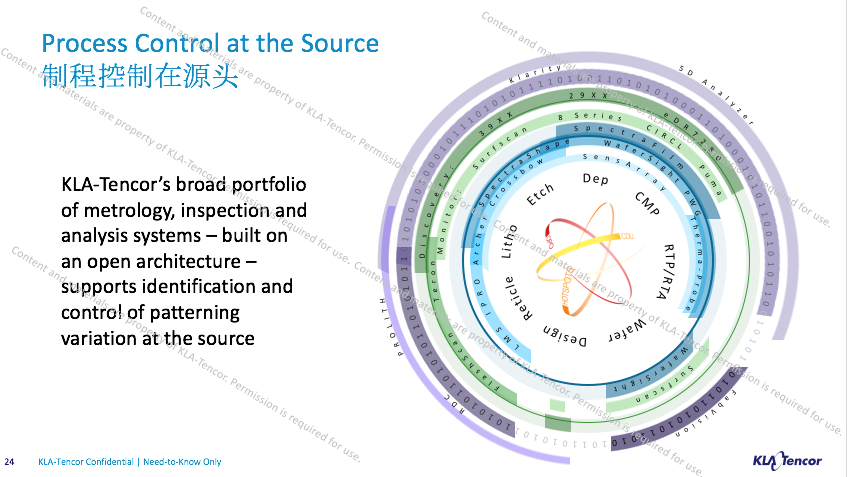


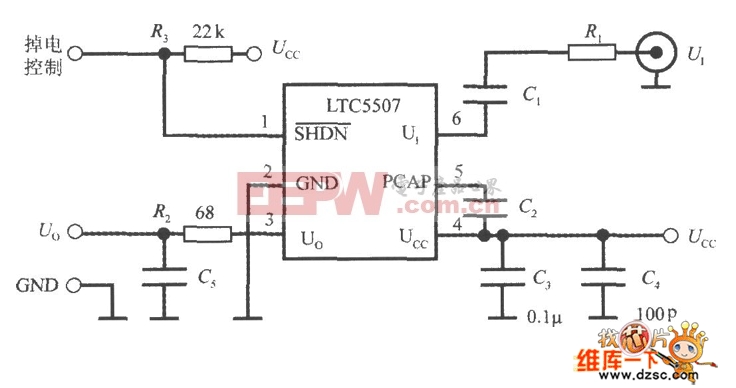
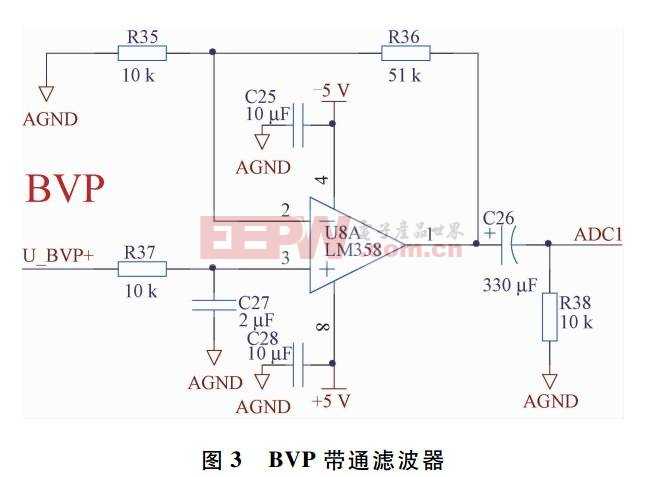

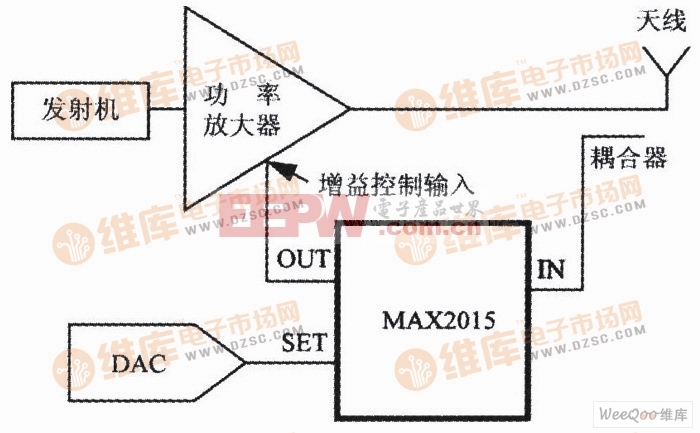

評論