硅片級可靠性測試詳解
斜坡電壓法
測試時使MOS電容處于積累狀態(tài),在柵極上的電壓從使用電壓開始掃描一直到氧化膜擊穿為止,擊穿點(diǎn)的電壓即為擊穿電壓(Vbd),同時我們還可以得到擊穿電量(Qbd)。按照J(rèn)EDEC標(biāo)準(zhǔn),用斜坡電壓法時,總的測試結(jié)構(gòu)的氧化膜面積要達(dá)到一定的要求(比如大于10cm2等)。做完所有樣品的測試后,對得到的擊穿電壓進(jìn)行分類:
● 擊穿電壓《使用電壓:早期失效;
● 使用電壓《擊穿電壓
● 擊穿電壓》m×使用電壓:本征失效
然后計(jì)算缺陷密度D:
D=(早期失效數(shù)+可靠性失效數(shù))/總的測試面積;
如果D《 D0,則通過;
如果D》D0,則沒有通過。
此外,得到的擊穿電量也可以作為判定失效類型的標(biāo)準(zhǔn),一般當(dāng)Qbd《0.1C/cm2 就認(rèn)為是一個失效點(diǎn),但是當(dāng)工藝在0.18μm以上,Qbd一般只是作為一個參考,并不作為判定標(biāo)準(zhǔn),因?yàn)镼bd和很多測試因素有關(guān)。
恒定電壓法
在柵極上加恒定的電壓,使器件處于積累狀態(tài)。這就是一般所說的TDDB(time dependent dielectric breakdown )。經(jīng)過一段時間后,氧化膜就會擊穿,這期間經(jīng)歷的時間就是在該條件下的壽命。在測得三個高于使用電壓的電壓的壽命后,用一定的模型就可以推得在使用條件下的壽命。推算TDDB壽命的模型主要有兩種,E模型和1/E模型。已有的研究表明,在不同的電場下TDDB壽命符合不同的模型,在低場下符合E模型,在高場下符合1/E模型,這就給使用條件下的TDDB壽命的推算帶來很大麻煩。為了使用E模型,必須測得在較低電場下的TDDB壽命,但是這樣的話就要花費(fèi)相當(dāng)大的測試時間,這是目前需要解決的一個問題。
熱載流子效應(yīng)
隨著MOSFET器件尺寸的不斷縮小,熱載流子效應(yīng)嚴(yán)重地影響器件與電路地可靠性。對熱載流子效應(yīng)的研究已經(jīng)成為MOSFET可靠性研究地?zé)狳c(diǎn)之一。工藝和器件工程是在調(diào)整工藝和器件參數(shù)時,必須考慮到熱載流子效應(yīng)。薄柵器件熱載流子效應(yīng)引起器件退化的主要因素有三個:1、氧化層中的電荷注入與俘獲;2、電子和俘獲空穴復(fù)合引起的界面態(tài);3、高能粒子打斷Si-H鍵引起的界面態(tài)。
熱載流子效應(yīng)研究的主要目的之一是建立壽命的可靠性預(yù)測模型。在實(shí)際運(yùn)用中,一般有兩種模型:Isub 模型和Isub/Id模型。因?yàn)閷τ赑MOS,熱載流子效應(yīng)不是非常明顯,所有對于PMOS,一般會對其進(jìn)行閾值電壓穩(wěn)定性或者NBTI (negative bias temperature instability)的測試。對這些項(xiàng)目的測試方法和要求JEDEC標(biāo)準(zhǔn)都給出了較為詳細(xì)的規(guī)定。
等離子損傷
等離子工藝已經(jīng)成為現(xiàn)代集成電路制造中不可缺少的一部分。 它具有很多優(yōu)點(diǎn),如方向性好,實(shí)現(xiàn)溫度低,工藝步驟簡單等,但同時它也帶來很多對MOS器件的電荷損傷。隨著柵極氧化膜厚度的減小,這種損傷就越來越不能被忽視。它可以劣化柵極氧化膜的各種電學(xué)性能,如:氧化層中的固定電荷密度、界面態(tài)密度、平帶電壓、漏電流等以及和擊穿相關(guān)的一些參數(shù)。導(dǎo)致等離子損傷的本質(zhì)原因是等離子中正離子和電子分布不均勻。在局部區(qū)域,正離子和電子的分布可能是不平衡的,至少在剛開始的時候是可能的,這些非平衡電荷會對非導(dǎo)體表明充電,電荷積累到一定程度后就會發(fā)生F-N 電流,造成對柵極氧化層的損傷。而正離子和電子分布不均勻會主要發(fā)生在多晶硅和金屬刻蝕時以及光刻膠剝離時。






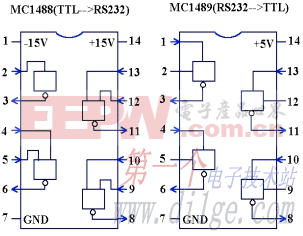
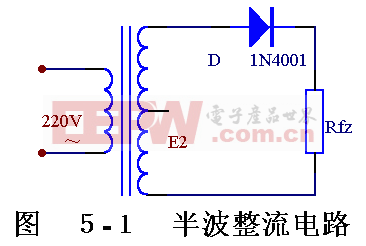
評論