后摩爾定律時代 電子制造產業鏈走勢分析
摩爾定律作為電子制造產業鏈的金科玉律,一直屹立于科技發展的前沿,給整個電子制造產業鏈指明了非常明晰的發展方向,可謂厚澤萬物。但近些年,由于IC制造過程中使用的光刻技術(Photolithography)相對于摩爾定律顯得相對滯后,IC業界給予厚望的EUV(Extreme UltraViolet)光刻設備也在緊鑼密鼓的研發中,技術成熟度尚達不到量產的水平,使得IC制造成本在晶圓節點(Wafer Node)不斷縮小的情況下,成本呈現指數增長;另一方面,2017年,蘋果A11/A10X、高通驍龍835、三星Exynos 8895、華為Kirin970和聯發科Helio X30蓄勢待發,晶圓節點已經發展到10nm量產的階段,已經非常接近FinFET制程的物理極限5nm,因此即便EUV光刻設備可以量產使用,也無法改變摩爾定律即將死亡的趨勢。那接下來電子制造行業該何去何從?業界和學界也給出了比摩爾定律更為多元化的答案:more moore(深度摩爾,IC制造角度的摩爾定律)和more than moore(超越摩爾,IC封裝角度的摩爾定律),見圖1:
本文引用地址:http://www.104case.com/article/201705/358673.htm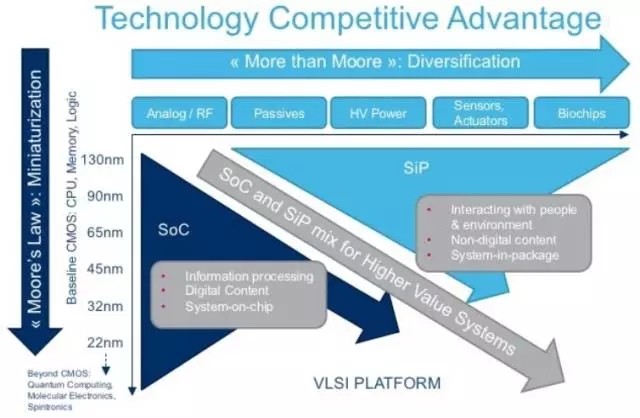
圖 1 后摩爾定律時代Roadmap
何謂深度摩爾(more moore,IC制造角度的摩爾定律),是延續CMOS(FinFET)的整體思路,在器件結構、溝道材料、連接導線、高介質金屬柵、架構系統、制造工藝等等方面進行創新研發,沿著摩爾定律一路scaling(每兩到三年左右,晶體管的數目翻倍),見圖2 Logic IC的roadmap:
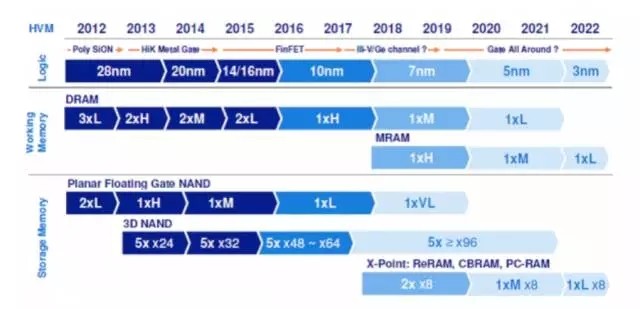
圖 2 Wafer Node Roadmap
目前深度摩爾一般適用于數字電路,如智能手機中的處理器(AP)和基帶芯片(Base Band),均屬于SoC的范疇。前面我們也提到,由于FinFET的物理極限是5nm,那么發展到5nm后如何繼續呢?那就必須打破FinFET的結構和材料限制,開發和研究新的Transistor(switch)形式,如Tunneling FET(TFET)、Quantum Cellular Automata (QCA) 、SpinFET等,也即圖1中所謂的Beyond CMOS。
何謂超越摩爾(more than moore,IC封裝角度的摩爾定律),主要側重于功能的多樣化,是由應用需求驅動的。之前集成電路產業一直延續摩爾定律而飛速發展,滿足了同時期人們對計算、存儲的渴望與需求。但芯片系統性能的提升不再靠單純的暴力晶體管scaling,而是更多地依靠電路設計以及系統算法優化,同時集成度的提高不一定要靠暴力地把更多模塊放到同一塊芯片上,而是可以靠封裝技術來實現集成。模擬/射頻/混合信號模塊等不需要最先進工藝的模塊可以用較成熟且廉價的工藝實現(比如為模擬射頻工程師所喜聞樂見的65nm),而數字模塊則可以由先進工藝實現,不同模塊可以用封裝技術集成在同一封裝中,而模塊間的通訊則使用高速接口。這種集成方式即異質集成(heterogeneous integration),是目前在工業界和學界都非常火的SiP,不但可以減低成本,而且可以更加集成化,見圖3(b)。智能手機中的射頻前端模塊、WiFi模塊、藍牙模塊和NFC模塊等模擬電路均適用于超越摩爾的情景。
回頭再看摩爾定律的兩個方向,無非就是SoC和SiP的差異,一個是IC設計角度,一個是IC封裝角度,見圖3,也可是數字電路與模擬電路的差異。這樣,再去理解SoC和SiP何其簡單。
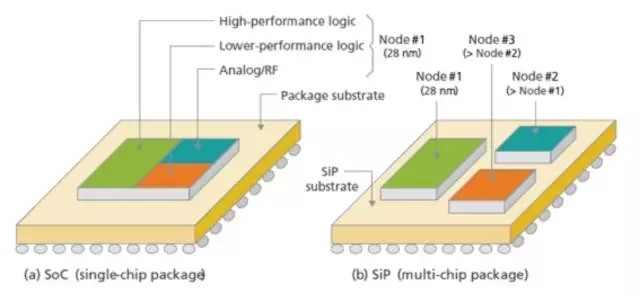
圖 3 SoC與SiP
那我們再把視線從理論預測轉向實際應用,作為消費電子時代的弄潮兒蘋果公司自然是大家討論技術走向的焦點。隨著蘋果公司發布iPhone 10周年的臨近,紀念版iPhone的消息更是紛至沓來,讓人目不暇接,其最新技術走向更是值得大家分析揣測。
首先就是2016年9月iPhone 7的A10 Fusion首次采用TSMC 16nm 的InFoWLP封裝技術,完全取代了以往的FCCSP的封裝技術,而今年9月即將發布的紀念版iPhone A11將采用TSMC 10nm的InFoWLP封裝技術,而與之對應的主板則會革命性地將載板的精細線路制造技術MSAP導入PCB行業,重新定義了電子制造產業鏈,由于原來的IC制造(TSMC)→IC封裝(ASE)+IC載板→SMT(Foxconn)+PCB的制造流程改為IC制造(TSMC)→ SMT(Foxconn)+PCB,也即把IC封裝融入IC制造,PCB直接代替IC載板。那我們不難發現,這種是基于深度摩爾由于AP 升級(16nm至10nm)而帶來的革命性改變。
其次是蘋果Apple Watch的發布,其最具特色的就是S1芯片(見圖4)的封裝技術,即SiP封裝技術(System in Package),不但把AP應用處理器(已經集成了SRAM內存)、NAND閃存、各種傳感器、特殊用途芯片、IO及功耗管理IC封裝到了一起,而且還把其他被動原件均集成在一塊載板上,在這里其主板客串了兩個角色:IC載板和PCB主板,其整個電子制造產業鏈也由傳統的IC制造(TSMC)→IC封裝(ASE)+IC載板→SMT(Foxconn)+PCB縮短為IC制造(TSMC)→IC封裝(ASE)+IC載板,也即把SMT流程全部整合入IC封裝,并采用IC載板代替PCB主板。從此我們也不難看出,這種就是基于超越摩爾由于封裝技術的革新而帶來的革命性整合。

圖 4 Apple Watch S1
從以上蘋果公司最新的技術應用分析,我們可以看出,蘋果、臺積電、日月光和富士康四親兄弟分別代表著IC設計、IC制造、IC封裝和SMT四個領域正忠實地沿著深度摩爾和超越摩爾的路線前行,引領者整個電子制造行業的發展與變革,同時也潛移默化地影響著PCB制造者和IC載板制造者。作為PCB制造的從業者,更需要擦亮眼睛,做到envision it,enable it,只有這樣才能永葆。下面我將從IC封裝和IC載板技術方面談起,更詳細地介紹Fan-Out WLP、SLP和SiP,為PCB產業后續發展和遠景規劃提供建議。
IC封裝技術發展趨勢(含IC載板、Fan-Out WLP、SLP和SiP)
電子制造產業鏈包含前端的高端電子產業鏈(IC設計、IC制造和IC封裝)和后端的SMT貼件及組裝,所以IC封裝技術屬于高端電子制造領域極其重要的一環,其技術發展趨勢同樣受摩爾定律的影響,當然現階段同樣受困于摩爾定律的局限性影響。隨著高速數據傳輸的需求及無線技術的飛速發展,沿著深度摩爾的方向,芯片尺寸不斷縮小,I/O數不斷增加,傳統的IC封裝正逐漸由Lead frame、Wire Bonding轉向Flip Chip,見圖5,從而避免互聯通道過長對數據傳輸通道造成的信號損失;當IC制造受到諸多限制因素,摩爾定律逐漸趨緩時,人們不得不開辟超越摩爾的發展道路,從最初的單個IC對應單個載板的封裝走向多個IC對應單個載板的SiP封裝(2D、2.5D、3D封裝)。
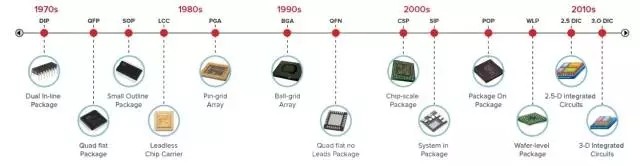
圖 5 封裝技術發展Timeline
為了更詳細的了解IC封裝技術及其所包含的IC載板技術,我們需要將視角由摩爾定律轉向IC實際應用。縱觀ICT時代,電子制造技術的主要驅動來源于兩個方面:第一,以智能手機為核心的消費電子,第二,以大數據云計算為核心的高性能計算機,不同的應用對應不同的IC封裝和IC載板,見圖6:
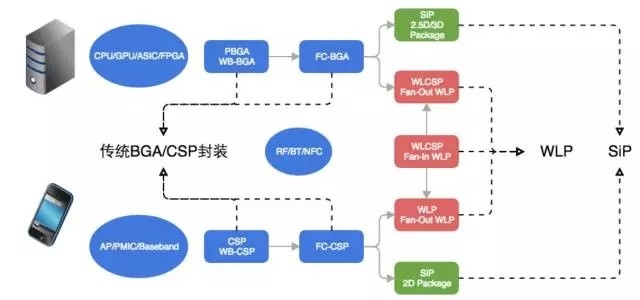
圖 6 IC封裝應用及演變趨勢
從圖中我們也可看出,主流IC封裝主要包括3個大類:傳統BGA/CSP封裝、WLP封裝和SiP,所以我將從以下三大類封裝闡述IC載板、SLP、FoWLP及SiP的差異。







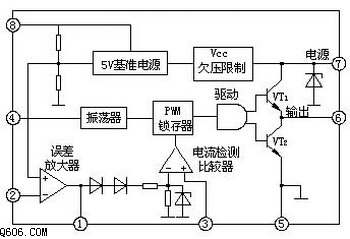

評論