散射方法測量嵌入式SiGe間隔結構
散射測量方法日益應用于復雜結構的測量,并逐漸在間隔層的量測中占據主導地位。數量級在10nm或更薄的間隔層測量尤其困難。除間隔層厚度外,由間隔層過刻蝕導致的基板凹陷深度也對器件有著明顯的影響。嵌入式SiGe通過刻蝕出溝道并填充SiGe來將其嵌入到SOI基板中,它的引入增加了測量的難度。和柵極電介質的底部相比,溝槽可能會出現欠填充或過填充的現象。對大量欠填充或過填充的測量對器件性能的監控是非常重要的。
本文引用地址:http://www.104case.com/article/195946.htm本文討論了用于測量eSiGe溝槽的復雜薄間隔PFET結構的散射測量方法。間隔層厚度和eSiGe溝槽的過填充量是該類結構的重要測量參數。通過測量關鍵參數,可以了解不同系統間測量性能上的差異。與舊系統比較,新系統的光學元件顯著提高了參數的動態可重復性,同時將波長范圍延伸到了深紫外光 (DUV),而這個波長范圍對測量參數有極大的靈敏度,顯著提高了測量的準確性。
實驗
本實驗主要對45nm節點SOI技術的NFET與PFET結構進行測量。每個結構包含一個間距為190nm的多晶硅柵極,其氧化物間隔層厚度約為10nm左右。測量的PFET 結構包含過填充的eSiGe。評估的參數包括PFET和NFET氧化物間隔層的厚度,以及PFET的過填充量。上述兩種結構樣本的TEM如圖1所示。
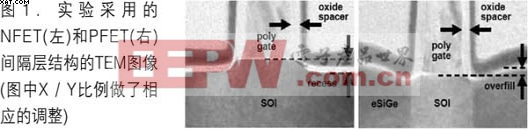
本實驗采用的樣品為經過間隔層刻蝕工藝的6枚晶圓。在這一組晶圓中,確保兩個參數不一樣,一個是間隔淀積厚度,它會形成不同厚度的間隔層;另一個是間隔層過刻蝕量,它會形成不同的NFET凹陷深度和PFET過填充量。采用的設備是Spectra CD200(SCD)散射測量系統和新一代平臺NGP。
本文把波長范圍在235nm以上的光源定義為“紫外光 (UV)”,而把波長范圍為150nm~235nm的光源定義為“深紫外光 (DUV)”。創建2個NFET模型并進行比較,每個系統均使用相同的波長,并確保所有波長在紫外光的范圍內。此外還采用相同的光學常數 (n&k),以及相同的固定和浮動模型參數。5個浮動參數分別是:氧化物間隔層厚度、柵極多晶硅關鍵尺寸的MCD、柵極多晶硅高度、SOI厚度和埋層氧化物厚度。
同樣也創建2個PFET模型,與NFET模型類似,也使用相同的固定與浮動模型參數。PFET模型中的7個浮動參數分別是氧化物間隔層厚度、柵極多晶硅 MCD、柵極多晶硅高度、SOI梯形高度、余下的SOI厚度、埋層氧化物厚度以及eSiGe過填充量。圖2 展示了NFET與PFET模型的示意圖。
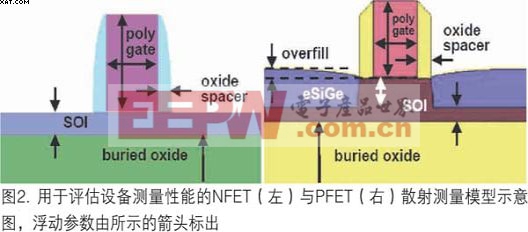
結果
光學常數的確定
由于光學常數或散射參數對最后的建模結果有著重大的影響,因此確定正確的光學常數或散射參數是非常關鍵的。確定SCD紫外光薄膜常數可采用常見的疊加堆棧辦法。這種方法是在有圖形的實驗晶圓上收集經過多個工藝步驟后的平坦薄膜區光譜,直至間隔層刻蝕。這一過程可以追蹤每一道工藝是如何影響不同材料的薄膜性能的。
確定NGP PFET模型的光學常數則更具挑戰性,因為實驗晶圓不能像SCD應用那樣,可在每個工藝步驟后測量。除帶有氧化物間隔層薄膜的無圖形晶圓外,所有薄膜光譜的收集只能在這6片晶圓的間隔層刻蝕之后,在三個不同的平坦襯底上進行。這些襯底的示意圖如圖3所示。利用在DUV與UV范圍測得的光譜數據創建合適的散射參數。換而言之,將來自這兩個波長區域的光譜首次進行合并,然后創建散射參數。此外,在這個合并后的光譜范圍內,同時對DUV與UV散射參數進行優化,而不是單獨優化,然后拼接在一起。雖然這種方法面臨更多的挑戰,但可以防止產生無規律的不連續光學常數,或在235nm躍遷波長處產生衍生數據。
DUV的穿透深度相對較淺,這樣可以在平坦襯底區獲得上層薄膜特性(圖3)。該上層薄膜特性獨立于下層薄膜特性以及由于受后續工藝步驟的影響而導致的不確定性。對比來看,UV和可見光具有更深的穿透深度,因此該光譜對下層薄膜的不確定性更敏感,更難以得到上層薄膜的特性。所以,缺乏適當的用于薄膜特征描述的晶圓可能會影響NGP PFET薄膜的散射質量,尤其是在UV波長范圍內。






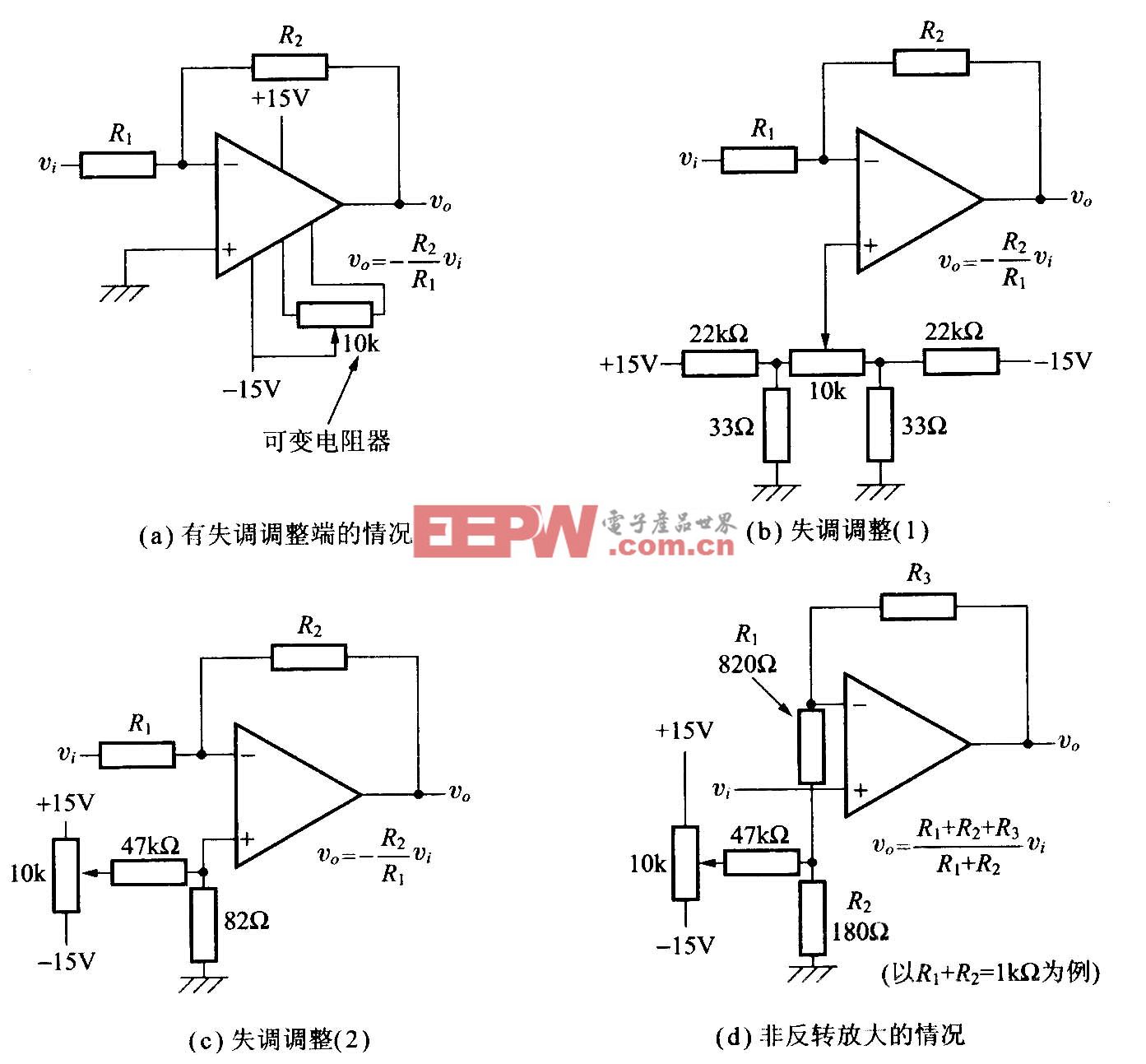






評論