常見PCB表面處理復合工藝分享
PCB表面處理復合工藝-沉金+OSP是一種常用于高端電子產品制造領域的工藝組合。這種復合工藝結合了沉金板和OSP(Organic Solderability Preservatives)工藝,以獲得更佳的綜合效果。
沉金板焊點的金屬間化合物(IMC)生長于鎳層上,而鎳錫間晶粒的機械強度稍弱于銅錫間晶粒的機械強度。沉金制程中,磷含量工藝的黑盤與高磷含量的金面不溶解的問題可能會出現,這是一個難以解決的問題。然而,沉金工藝仍然具有許多優點,例如平整的焊盤表面、金的抗氧化和低電阻率特性,以及較寬的制程窗口。
復合工藝的應用
為了兼顧機械強度和其他優點,智能手機制造業普遍采用復合型工藝,即沉金板+BGA區域焊盤采用OSP工藝。這種工藝使得BGA焊點直接生長于銅箔上,以確保其機械強度。復合型工藝制造流程相對復雜,起初應用于高端智能手機,逐漸被業界認可并流行于高端電子產品制造領域。
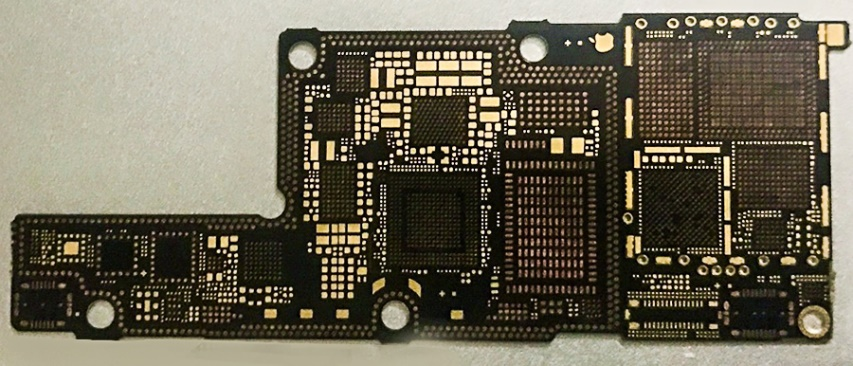
圖1. PCB表面處理復合工藝:蘋果手機主板;其中BGA焊盤為OSP工藝,其他區域焊盤表面處理ENIG
沉金工藝中的賈凡尼效應和金面不溶解問題
在使用沉金工藝后,金層表面的孔隙可能會暴露鎳層,這可能導致在腐蝕環境中發生賈凡尼效應(Galvanic Effect),從而使鎳溶解(金為陰極,鎳為陽極)。鎳的溶解會導致溶液中的銅離子同時還原并沉積在金表面上,導致金面皮膜的顏色變深,甚至出現金屬銅。一旦沉金后的表面存在銅,氧化后的銅會導致焊盤拒焊,從而出現金面不溶解的問題。這是需要注意的細節。
總之,化學鎳金板焊盤表面平整,適合密間距制程需求,可以烘烤和清洗,并具有較寬的制程窗口。金面可以用作接觸面或Wire bond基面,金的不易氧化變質的特性使沉金板具有良好的焊錫性能。
沉金工藝的常見不良情況
然而,化學鎳金板也存在一些常見的不良情況,包括沉金工藝控制異常導致的黑盤(焊接后掉件、焊點強度不足)、沉金工藝導致的金層夾雜有機物(拒焊、縮錫不良)、高磷含量工藝控制異常導致金層過薄(拒焊、縮焊,焊盤未呈金色)、PCB制程異常導致電鍍液殘留(拒焊、縮錫、異物污染)、沉金工藝控制不良導致鎳層氧化和污染(金層剝離、拒焊、縮錫)、沉金工藝控制異常導致鎳層開裂和與銅層分離(焊點可靠性異常)。這些問題需要在制程中進行關注和控制。
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。



