先進(jìn)封裝中銅-銅低溫鍵合技術(shù)研究進(jìn)展
來源:焊接學(xué)報(bào)
Cu-Cu 低溫鍵合技術(shù)是先進(jìn)封裝的核心技術(shù),相較于目前主流應(yīng)用的 Sn 基軟釬焊工藝,其互連節(jié)距更窄、導(dǎo) 電導(dǎo)熱能力更強(qiáng)、可靠性更優(yōu). 文中對(duì)應(yīng)用于先進(jìn)封裝領(lǐng)域的 Cu-Cu 低溫鍵合技術(shù)進(jìn)行了綜述,首先從工藝流程、 連接機(jī)理、性能表征等方面較系統(tǒng)地總結(jié)了熱壓工藝、混合鍵合工藝實(shí)現(xiàn) Cu-Cu 低溫鍵合的研究進(jìn)展與存在問題, 進(jìn)一步地闡述了新型納米材料燒結(jié)工藝在實(shí)現(xiàn)低溫連接、降低工藝要求方面的優(yōu)越性,概述了納米線、納米多孔骨 架、納米顆粒初步實(shí)現(xiàn)可圖形化的 Cu-Cu 低溫鍵合基本原理. 結(jié)果表明,基于納米材料燒結(jié)連接的基本原理,繼續(xù) 開發(fā)出寬工藝冗余、窄節(jié)距圖形化、優(yōu)良互連性能的 Cu-Cu 低溫鍵合技術(shù)是未來先進(jìn)封裝的重要發(fā)展方向之一.
0 序言
摩爾定律指出,集成電路上可容納的晶體管數(shù) 目及性能約每隔 18 ~ 24 個(gè)月便會(huì)提升一倍 . 隨 著大數(shù)據(jù)、5G、人工智能、移動(dòng)互聯(lián)網(wǎng)的迅猛發(fā)展, 尤其是工藝節(jié)點(diǎn)到 7 nm 之后,物理效應(yīng)、成本的限 制使得依靠光刻技術(shù)驅(qū)動(dòng)的摩爾定律明顯放緩. 在“后摩爾時(shí)代”,不再一味地追求更小的光刻工藝 節(jié)點(diǎn),而是依靠先進(jìn)封裝互連技術(shù)的創(chuàng)新來滿足系 統(tǒng)微型化、多功能化的需求,這將是集成電路制造 行業(yè)發(fā)展的重要方向之一 .
為了滿足高性能芯片的應(yīng)用需求,未來先進(jìn)封 裝互連技術(shù)將不斷向高密度、高可靠的方向發(fā)展. 高密度即指焊點(diǎn)節(jié)距將不斷減小至 10 μm 以下,焊 點(diǎn)密度超過 10 000 個(gè)/mm2 ;高可靠主要指焊點(diǎn)在 電流密度不小于 106 A/cm2 、服役溫度不低于 100 ℃ 等工況下服役時(shí)具有良好的穩(wěn)定性能,并伴隨應(yīng)用 領(lǐng)域?qū)﹄娮悠骷笤礁邉t上述服役參數(shù)將不斷 提升. 目前,主流應(yīng)用的先進(jìn)封裝互連技術(shù)為 Sn 基 釬料軟釬焊工藝 ,主要包括回流焊和波峰焊工藝, 其具有連接溫度低 (250 ~ 300 ℃)、成本低等優(yōu)勢(shì). 對(duì)于回流焊工藝,回流過程中可發(fā)生自對(duì)中效應(yīng)和 塌陷效應(yīng),降低了對(duì)設(shè)備對(duì)中精度和基板平整度 的要求. 然而,軟釬焊工藝也存在諸多局限性,比如 回流過程中易發(fā)生外溢效應(yīng),無法實(shí)現(xiàn)窄節(jié)距互 連;其接頭載流能力弱,易發(fā)生電遷移失效;界面 反應(yīng)易生成空洞和脆性相,引起機(jī)械可靠性降低等. 這些瓶頸導(dǎo)致軟釬焊工藝無法滿足未來先進(jìn) 封裝互連技術(shù)的發(fā)展要求. 近年來,Cu-Cu 鍵合 新方法發(fā)展迅速,無 Sn 元素的使用避免了上述問 題的出現(xiàn). 具體而言,Cu-Cu 鍵合具有以下優(yōu)勢(shì):① Cu 在鍵合過程中全程保持固態(tài),無軟釬焊的外 溢問題,可實(shí)現(xiàn)窄節(jié)距互連;② 具有優(yōu)異的導(dǎo)電、 導(dǎo)熱性能,良好的抗電遷移能力和熱機(jī)械可靠性;③ Cu 是半導(dǎo)體制造中的常用金屬,工藝兼容性好 且材料成本低廉. 綜合上述因素,Cu-Cu 鍵合技術(shù) 可滿足高密度、高可靠互連,未來最有可能獲得大 規(guī)模應(yīng)用. 然而,Cu-Cu 鍵合也面臨諸多新的挑戰(zhàn), 如銅的熔點(diǎn) (1 083 ℃) 高、自擴(kuò)散速率低,難以實(shí)現(xiàn) 低溫鍵合. 已有研究表明,Cu-Cu 直接鍵合需要在 400 ℃ 的高溫下才能充分發(fā)生原子擴(kuò)散,如此 高的溫度會(huì)導(dǎo)致降低對(duì)中精度、損傷器件性能、增 加設(shè)備要求等問題. 因此,如何實(shí)現(xiàn) Cu-Cu 低溫 鍵合已成為學(xué)術(shù)界和產(chǎn)業(yè)界共同關(guān)注的焦點(diǎn)之一.
目前,實(shí)現(xiàn) Cu-Cu 低溫鍵合的技術(shù)手段可分為 熱壓鍵合工藝、混合鍵合工藝、納米材料燒結(jié)工藝 三大類. 除了需滿足上述低溫需求外,新工藝還要 綜合考慮性能 (如強(qiáng)度、電阻)、可靠性、效率、成 本、工藝兼容性等因素. 文中將對(duì)這些工藝的方 法、原理進(jìn)行系統(tǒng)歸納、總結(jié),分析其實(shí)際應(yīng)用時(shí)存 在的工藝難點(diǎn),并展望了 Cu-Cu 低溫鍵合進(jìn)一步研 究的方向,以期對(duì)未來技術(shù)發(fā)展提供參考.
1 熱壓鍵合工藝熱壓鍵合工藝的基本原理與傳統(tǒng)擴(kuò)散焊工藝 相同,即上下芯片的 Cu 凸點(diǎn)對(duì)中后直接接觸,其實(shí) 現(xiàn)原子擴(kuò)散鍵合的主要影響參數(shù)是溫度、壓力、時(shí) 間. 由于電鍍后的 Cu 凸點(diǎn)表面粗糙并存在一定的 高度差,所以鍵合前需要對(duì)其表面進(jìn)行平坦化處 理,如化學(xué)機(jī)械拋光 (chemical mechanical polishing, CMP),使得鍵合時(shí) Cu 表面能夠充分接觸. 基于目 前研究文獻(xiàn),通過熱壓鍵合工藝實(shí)現(xiàn) Cu-Cu 低溫鍵 合的方法從機(jī)理上可分為兩類,即提高 Cu 原子擴(kuò) 散速率和防止/減少待鍵合 Cu 表面的氧化.

贊助商圖片廣告展示

1.1 提高 Cu 原子擴(kuò)散速率
Juang ,Shie ,Ong,Liu 等人提出了 電鍍晶粒呈現(xiàn)高度 (111) 取向的 Cu 凸點(diǎn)用于 CuCu 熱壓鍵合的方法,如圖 1 所示. 已有研究表明, 在 150 ~ 300 ℃ 條件下,Cu 原子在 (111) 晶面上的 擴(kuò)散速率比 (100)、(110) 晶面高 3 ~ 6 個(gè)數(shù)量級(jí),晶 粒呈現(xiàn)高度 (111) 晶向的 Cu 凸點(diǎn)可以有效提高 Cu 原子擴(kuò)散速率,降低鍵合溫度 . 利用晶粒定向 生長(zhǎng)的方法可以在 300 ℃,90 MPa,10 s 的條件下 完成快速鍵合,但是鍵合強(qiáng)度和導(dǎo)電性能較差. 為 此研究人員進(jìn)一步開發(fā)出了兩步鍵合工藝:首 先,電鍍后的 Cu 凸點(diǎn)進(jìn)行 CMP 并使用檸檬酸清洗 去除表面氧化物,并在 300 ℃,93 MPa,10 s 的條件 下進(jìn)行預(yù)鍵合;然后,在 300 ℃,47 MPa 的真空條 件下保溫 1 h 進(jìn)行退火處理,退火后的剪切強(qiáng)度達(dá) 103 MPa,導(dǎo)電性能進(jìn)一步改善. 圖 1d 顯示了退火 后晶粒會(huì)長(zhǎng)大至貫穿鍵合界面,從而可提高界面的結(jié)合強(qiáng)度.
此外,Sakai等人采用金剛石刀頭飛行切割 的方法對(duì) Cu 表面進(jìn)行整平,如圖 2 所示. 發(fā)現(xiàn)切 割后的 Cu 表面會(huì)出現(xiàn)由細(xì)晶粒構(gòu)成的薄層,細(xì)晶 層可提高晶界擴(kuò)散通量,因而降低 Cu-Cu 鍵合的溫度. 最終鍵合在 200 ℃,30 min,300 MPa 的條件下 完成,且界面處原子相互擴(kuò)散形成了新的晶粒. 研 究人員還比較了飛行切割與 CMP 處理后的 CuCu 鍵合強(qiáng)度,結(jié)果表明,200 ℃ 連接條件下,前者 的強(qiáng)度比后者高出近一倍. 此外,Al Farisi 等人將該方法用于密封,飛行切割后的 Cu 密封條可在 250 ℃ 的低溫下實(shí)現(xiàn)鍵合,從而減少密封過程中的 氣體解吸附,降低腔體內(nèi)的氣壓. 從圖 3 可以看到, 飛行切割后的 Cu 表面晶粒發(fā)生了明顯細(xì)化.
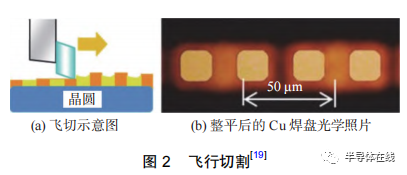
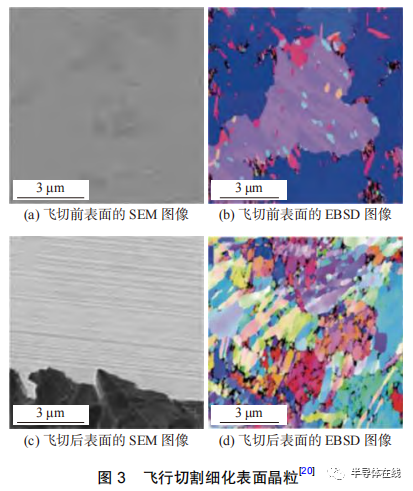
進(jìn)一步地,為降低對(duì) CMP/飛行切割整平工藝 的依賴,Yang,Chou等人提出了插入式 CuCu 鍵合工藝,其原理如圖 4 所示. 首先通過電鍍工 藝制作出異型結(jié)構(gòu)的待鍵合 Cu 表面,一面直徑較 小的 Cu 為突出結(jié)構(gòu),另一面直徑較大的 Cu 為凹陷 結(jié)構(gòu),二者對(duì)中后形成插入式結(jié)構(gòu). 在加壓過程中突出結(jié)構(gòu)的 Cu 和凹陷結(jié)構(gòu)的 Cu 發(fā)生相對(duì)滑移和 應(yīng)力集中,產(chǎn)生一定的熱效應(yīng),加速原子擴(kuò)散. 這種 方法可以在 150 ℃ 的條件下完成鍵合,鍵合后的界 面如圖 5 所示. 可靠性測(cè)試表明,該方法經(jīng)過 1 000 個(gè) 熱 循 環(huán) 測(cè) 試 (thermal cycling test, TCT, ?55 ~ 125 ℃) 和 96 h,130 ℃,85% 濕度的加速老化測(cè)試 (highly accelerated stress Test,HAST) 后,接頭電阻 無明顯變化. 這種方法無需 CMP 工藝,對(duì)待鍵合表 面的粗糙度有一定容忍度. 但是 ,為了使上下 Cu 結(jié)構(gòu)發(fā)生較大塑性變形而充分接觸,需要施加 高達(dá) 500 MPa 以上的壓力.
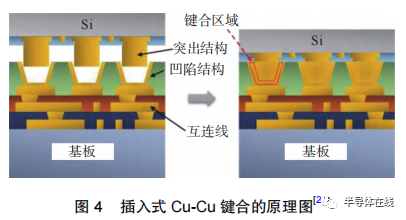
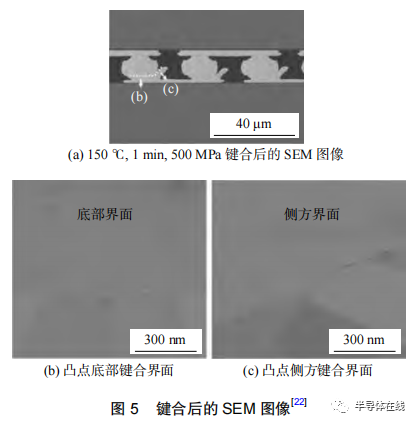
1.2 防止/減少待鍵合表面氧化
Cu 在高溫鍵合的情況下容易發(fā)生氧化,阻礙Cu 原子的擴(kuò)散. Takagi,Suga,Shigetou等人 提出了表面活化鍵合 (Surface Activated Bonding, SAB) 的方法. 該方法在超高真空條件下 (10?8 torr) 采用等離子體轟擊待鍵合 Cu 表面,去除氧化物和 其他污染物,達(dá)到原子級(jí)的表面清潔度,并在室溫、 無壓力條件下進(jìn)行預(yù)鍵合. 室溫條件鍵合可以保證 有更好的對(duì)中精度,報(bào)道中 SAB 可實(shí)現(xiàn) 6 μm 的窄 節(jié)距互連. 由圖 6 可以看到,預(yù)鍵合后仍存在明顯 界面,所以該方法往往需要 250 ~ 300 ℃ 的高溫退 火. SAB 表面處理和鍵合過程都需要在高真空條件 下完成,對(duì)設(shè)備要求非常高.
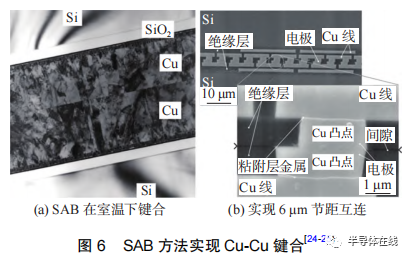
此外,研究人員提出了使用 Ti,Au,Ag, Pd等金屬在 Cu 表面制作鈍化層的方法,其鍵合原理如圖 7 所示. Cu 表面的金屬鈍化層及可有效 防止 Cu 被氧化,在鍵合過程中金屬鈍化層會(huì)向 Si 基底一側(cè)移動(dòng),而 Cu 原子會(huì)向鍵合界面遷移,最 終完成 Cu-Cu 鍵合.
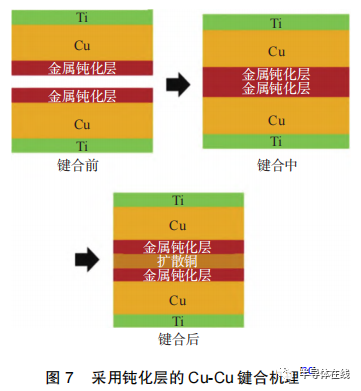
如圖 8 為 Ti 作鈍化層的鍵合結(jié)果,在 180 ℃, 1.91 MPa,30 ~ 50 min 的鍵合條件下,Ti 向 Si 基底 的方向移動(dòng)了約 50 nm,鍵合界面處為 Cu. 鍵合后 經(jīng)過 500 個(gè) TCT(?55 ~ 125 ℃) 和 96 h,130 ℃,85% 濕度的 HAST 后,接頭電阻無明顯變化.
此外,Peng,Tan等人還提出了采用自組 裝 分 子 層 (self-assembled monolayer, SAM) 鈍 化 Cu 表面防止氧化的方法,如圖 9 所示. 在鍵合前, 晶圓放入烷烴硫醇溶液中進(jìn)行浸泡從而在 Cu 表面 形成鈍化保護(hù). 鍵合過程首先升溫至 250 ℃,該溫 度下有機(jī)物鈍化層會(huì)自行分解,隨后將分解產(chǎn)物抽 走后,Cu-Cu 鍵合過程在 300 ℃,1 h,2 500 mbar 真 空條件下進(jìn)行. 圖 10 為無鈍化保護(hù)和有自組裝分 子層保護(hù)的鍵合界面對(duì)比,可以看到無鈍化保護(hù)的鍵合界面依然明顯,而鈍化保護(hù)的條件下界面基本消失.
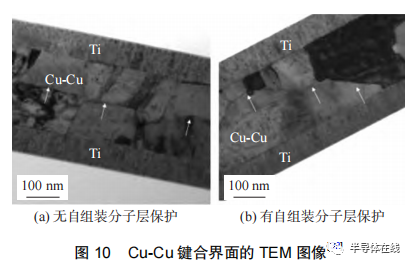
窄節(jié)距互連尤其節(jié)距小于 10 μm 的情況下, Cu-Cu 鍵合后的片間間隙很小,難以填充下填料. 混合鍵合工藝可分別實(shí)現(xiàn) Cu 和 Cu 之間的鍵合以 及 Cu 周圍介質(zhì)和介質(zhì)之間的鍵合,鍵合后的介質(zhì) 可起到下填料的作用,減緩熱應(yīng)力的同時(shí)保證更高 的鍵合強(qiáng)度、散熱能力和防止 Cu 凸點(diǎn)被腐蝕. 典 型的混合鍵合包括 Cu/SiO2 和 Cu/粘結(jié)劑鍵合兩 種. Cu/SiO2 混合鍵合的關(guān)鍵是得到平整度高、粗糙度小、親水性的表面,鍵合前需對(duì) SiO2 表面進(jìn)行 激活;Cu/粘結(jié)劑混合鍵合基于熱壓鍵合機(jī)理,Cu/ 熱固性的粘結(jié)劑通過加熱加壓的方法鍵合在一起.
2.1 Cu/SiO2 介質(zhì)的混合鍵合
Cu/SiO2 鍵合后可以得到無縫隙的鍵合界面, 能有效提高熱/機(jī)械可靠性. 目前,關(guān)于 CuCu 鍵合的研究很多,如前述晶面定向生長(zhǎng)、表面鈍 化等,然而其中相當(dāng)一部分工藝無法直接移植到 Cu/SiO2 混合鍵合. 這是因?yàn)?nbsp;Cu/SiO2 混合鍵合需 要綜合考慮 Cu-Cu 及 SiO2 -SiO2 鍵合 ,面臨工藝 兼容的挑戰(zhàn). 目前,實(shí)現(xiàn) Cu/SiO2 混合鍵合的方 法包括表面激活、直接鍵合技術(shù) (Direct Bonding Interconnect,DBI)、表面活化鍵合 (SAB) 等.
2.1.1 基于表面激活的混合鍵合
表面激活是指采用等離子體對(duì)晶圓表面進(jìn)行 處理,清潔晶圓表面并使其活化,研究中采用的等 離子體包括 O2 ,H2 ,N2,NH3 ,Ar等. 如 圖 11 所示,等離子體活化可以提高 SiO2 表面的羥 基密度,使得 SiO2 可在室溫下實(shí)現(xiàn)親水性預(yù)鍵合, 并在隨后 200 ~ 400 ℃ 的退火過程中脫水達(dá)成更可靠的共價(jià)鍵連接. 基于表面激活的混合鍵合的難 點(diǎn)之一是等離子體處理會(huì)對(duì) Cu 表面產(chǎn)生不利影 響,例如使用 O2 等離子體會(huì)氧化 Cu,即便是 Ar 等 離子體處理時(shí)腔體內(nèi)含有的氧也會(huì)對(duì) Cu 表面造成 氧化;使用 N2,NH3 等處理會(huì)使得 Cu 表面生成 氮化物,影響 Cu-Cu 鍵合.

2.1.2 基于 DBI 的混合鍵合
Co,Enquist等人提出了 DBI 的混合鍵合方法 ,其具體工藝流程如圖 12 所示. 首先通過濺 射、電鍍等半導(dǎo)體工藝在晶圓表面制作 Cu 凸點(diǎn),隨 后沉積 SiO2 介質(zhì)層覆蓋 Cu 凸點(diǎn)及晶圓表面,接著使用標(biāo)準(zhǔn) CMP 工藝露出晶圓表面的 Cu 焊盤并對(duì) 焊盤和 SiO2 介質(zhì)進(jìn)行整平. 在 CMP 過程中,拋光 液作用于 Cu 表面使其高度略低于 SiO2 表面. 在鍵 合前使用等離子體對(duì) SiO2 表面進(jìn)行激活,使其 可在室溫、無壓條件下完成預(yù)鍵合.預(yù)鍵合后需 要在 300 ~ 350 ℃ 下進(jìn)行退火,退火可以提高 SiO2 - SiO2 之間的鍵合強(qiáng)度,并使得 Cu 焊盤高溫膨脹相 互擠壓,完成 Cu-Cu 鍵合. 圖 13 為鍵合后的界面, Cu-Cu 及 SiO2 -SiO2 鍵合界面都沒有縫隙存在. DBI 由于在室溫下完成預(yù)鍵合,所以可以保證很高 的對(duì)中精度,報(bào)道稱其可實(shí)現(xiàn) 3 μm 的互連節(jié)距. DBI 具有良好的可靠性,鍵合后經(jīng)過 2 000 個(gè) TCT (?40 ~ 150 ℃) 和 2 000 h,275 ℃ 的高溫存儲(chǔ)后,接 頭電阻分別下降了 1.2% ~ 1.7% 和 1.2% ~ 1.4%, 滿足相關(guān)標(biāo)準(zhǔn)中電阻升高小于 10% 的要求.
2.1.3 基于 SAB 的混合鍵合
Utsumi等人提出了一種基于 Ar 等離子體 的 SAB 混合鍵合方法. 此前研究中發(fā)現(xiàn),超高真空 下采用 Ar 等離子體轟擊可以實(shí)現(xiàn) Cu-Cu,Si-Si 之 間的鍵合,但對(duì) SiO2 -SiO2 之間的鍵合效果較差. 為 了提高 SiO2 -SiO2 之間的鍵合質(zhì)量 ,研究人員在 SiO2 表面濺射了約 12 nm 的 Si 作為中間層,隨后 經(jīng)過 SAB 處理并在室溫下鍵合. TEM 觀察發(fā)現(xiàn), 鍵合后的界面為厚度約 7 nm 的非晶 Si 薄層 (如 圖 14 所示),鍵合強(qiáng)度約為 25 MPa. 這種方法也會(huì) 在 Cu 表面引入 Si 層,在一定程度上降低 Cu 的導(dǎo) 電性.
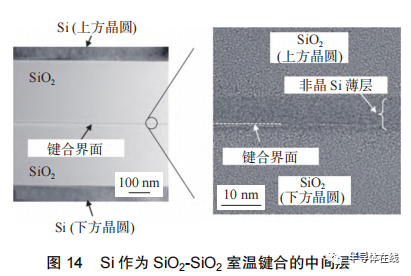
進(jìn)一步地,He 等人提出了采用含 Si 的 Ar 等離子體處理待鍵合表面的工藝方法,如圖 15 所示. 含 Si 等離子體可提高 SiO2 表面的 Si 點(diǎn)位, 促進(jìn) SiO2 -SiO2 鍵合. 表面處理后分兩條工藝路線 進(jìn)行晶圓鍵合,一種是直接在 5 × 10?6 Pa 的高真空 下直接進(jìn)行室溫鍵合,另一種為采用預(yù)鍵合-分離- 最終鍵合的多步路線進(jìn)行親水性鍵合:(1) 將處理 后的晶圓置于真空度為 2 × 10?2 Pa 的腔室內(nèi),隨后 向腔室內(nèi)充入潮濕的 N2 至 3 kPa,接著沖入干燥氮 氣至大氣壓,晶圓取出后采用純水沖洗并甩干; (2) 在大氣 (濕度約為 40%)、常溫、無壓條件下對(duì)晶圓進(jìn)行預(yù)鍵合,并在大氣下保存 10 min 以上;(3) 將 預(yù)鍵合后的晶圓轉(zhuǎn)移至鍵合腔室內(nèi),并在 10?2 Pa 的條件下分離預(yù)鍵合的晶圓;(4) 在 10?2 Pa 真空 度 ,200 ℃,2.5 MPa,30 min 的條件下進(jìn)行最終 鍵合并在大氣壓下 200 ℃ 退火 2 h. 強(qiáng)度測(cè)試表 明,預(yù)鍵合—分離—最終鍵合的方法可實(shí)現(xiàn) 2.0 ~ 2.5 J/m2 結(jié)合能的 SiO2 -SiO2 鍵合,優(yōu)于高真空直接 鍵合的 0.5 J/m2 . 這是由于該方法可以在最終鍵合 前增加?OH 吸附及去除表面 H2O 分子,更有利于 提高鍵合強(qiáng)度、減少界面空洞. 此外,這種方法也可 以得到低含氧量的 Cu-Cu 鍵合界面.
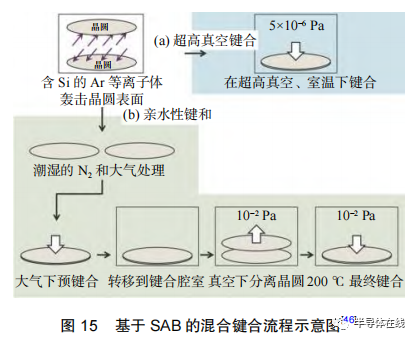
2.2 Cu/粘結(jié)劑介質(zhì)的混合鍵合
Cu/粘結(jié)劑介質(zhì)的混合鍵合與 Cu/SiO2 混合 鍵合類似 ,只是使用粘結(jié)劑如 BCB, PBO, PI等替代了 SiO2 介質(zhì) (圖 16),粘結(jié)劑具有更好 的柔性,可以一定程度上容忍介質(zhì)表面的微塵顆粒物.
Cu/粘結(jié)劑混合鍵合主要基于熱壓的方法,實(shí) 現(xiàn)方式包括兩種:①粘結(jié)劑先鍵合,如圖 17a 所 示. 在較低的溫度下 (約 250 ℃,取決于粘結(jié)劑的種 類) 首先將粘結(jié)劑鍵合并固化,此時(shí) Cu-Cu 尚未完 成鍵合,然后在更高的溫度 (350 ~ 400 ℃) 下進(jìn)行 熱壓實(shí)現(xiàn) Cu-Cu 鍵合,粘結(jié)劑在低溫下鍵合可以防 止更高的 Cu 鍵合溫度對(duì)未固化的粘結(jié)劑造成損 傷. 不過這種方法存在諸多不足,如需選擇耐高溫 的粘結(jié)劑材料、粘結(jié)劑需要較長(zhǎng)的固化時(shí)間導(dǎo)致鍵 合效率降低等. ② Cu 先鍵合,如圖 17b 所示.
Cu 首先在低于粘結(jié)劑固化的溫度下短時(shí)鍵合 (如 ≤10 min),隨后在更高的溫度下對(duì)粘結(jié)劑進(jìn)行固化 且進(jìn)一步提高 Cu-Cu 鍵合的強(qiáng)度. 實(shí)現(xiàn) Cu-Cu 低 溫鍵合的方法需要考慮到對(duì)粘結(jié)劑表面的影響,如 Ar 原子束和 Ar 等離子體處理雖然可以降低 CuCu 鍵合的溫度,但激發(fā)出來的金屬離子卻會(huì)污染 粘結(jié)劑表面,干擾粘結(jié)劑的鍵合. 為此,有研究人 員采用 Pt 催化后含 H 的甲酸對(duì) Cu 和粘結(jié)劑表 面進(jìn)行處理,可以在 200 ℃,5 min 條件下完成 Cu-Cu 鍵合,并且不會(huì)對(duì)粘結(jié)劑鍵合產(chǎn)生不利影響.
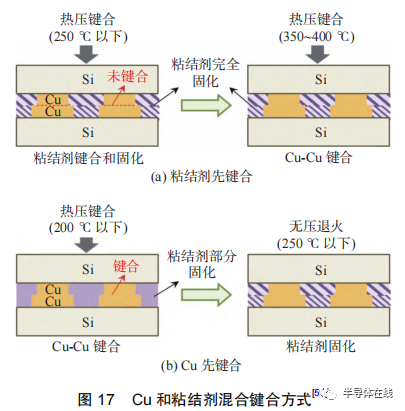
3 熱壓鍵合和混合鍵合的工藝難點(diǎn)
前述分別匯總了 Cu-Cu 熱壓鍵合、混合鍵合方 法的研究現(xiàn)狀. 目前大部分研究還僅僅停留在實(shí)驗(yàn) 室階段,需要進(jìn)一步深入對(duì)工藝和機(jī)理的探討. 與 此同時(shí),當(dāng)前這些方法也面臨著共性的工藝難點(diǎn), 包括以下兩方面:
3.1 工藝要求非常苛刻
無論是熱壓鍵合還是混合鍵合方法對(duì)待鍵合表 面的質(zhì)量如粗糙度、光潔度、晶圓整體翹曲程度有 很高要求. 由于制作完成的 Cu 表面為粗糙狀態(tài)且 有一定的高度差,需要經(jīng)過昂貴、復(fù)雜的 CMP、飛行 切割等整平工藝對(duì)待鍵合表面進(jìn)行平坦化,降低表 面粗糙度和高度差. 此外,晶圓本身還具有一定的 翹曲,尤其是面積大、厚度薄的晶圓,翹曲程度會(huì)更 加明顯,Cu-Cu 鍵合的“硬碰硬”接觸方式易在鍵 合良率方面出現(xiàn)問題. 在低溫互連方面,為了實(shí)現(xiàn) 300 ℃ 以下的低溫互連,增大界面接觸面積,往往需 要增加鍵合壓力至 100 MPa 以上,這樣大的壓力可 能會(huì)導(dǎo)致晶圓碎裂或介質(zhì)層開裂、變形等問題,不能 滿足工藝要求. 此外,混合鍵合中 Cu-Cu鍵合和介 質(zhì)-介質(zhì)鍵合二者常常會(huì)相互干擾,需要兼顧兩方面 的鍵合要求,對(duì)材料、工藝都提出了很大挑戰(zhàn).
3.2 難以靈活適用于 2.5D 互連
Cu/介質(zhì)混合鍵合技術(shù)近年來發(fā)展迅速,部分 混合鍵合技術(shù)已在實(shí)際制造中應(yīng)用于 3D 互連的晶 圓鍵合 (Wafer to Wafer,W2W). 然而,混合鍵合 技術(shù)對(duì)待鍵合表面的微塵顆粒物很敏感. 即便如 Cu-粘結(jié)劑混合鍵合可以容忍一定的微塵顆粒物, 但如果顆粒物出現(xiàn)在 Cu 表面,仍會(huì)嚴(yán)重影響鍵合 質(zhì)量. 在 2.5D 互連的芯片-晶圓鍵合 (Chip to Wafer, C2W) 場(chǎng)合中,晶圓需要切割成單個(gè)芯片再鍵合到 載板晶圓表面,切割過程中不可避免地會(huì)引入微顆 粒物等,混合鍵合技術(shù)難以適用. 此外,2.5D 互連 主要是為了實(shí)現(xiàn)芯片功能整合,需要貼裝的芯片種 類非常多樣化,往往來自不同晶圓制造廠商,下游 的封裝廠很難說服上游晶圓廠改變制程來適應(yīng)混 合鍵合的工藝需求.
4 Cu納米材料燒結(jié)連接近年來,基于 Cu 納米材料燒結(jié)連接實(shí)現(xiàn) CuCu 鍵合逐漸獲得關(guān)注. 與熱壓鍵合和混合鍵合相 比,納米材料燒結(jié)對(duì)待鍵合表面的粗糙度、平整度 等有更高的適應(yīng)性,能夠大幅降低工藝要求.
4.1 納米材料燒結(jié)連接的基本原理
納米材料相對(duì)于宏觀塊體材料,表面原子占比增多,具有更高的表面能 ,更易發(fā)生原子擴(kuò)散,非 常有利于在低溫下進(jìn)行燒結(jié)連接.
以金屬納米顆粒為例,其燒結(jié)過程可以用經(jīng)典 粉末燒結(jié)理論進(jìn)行描述. 根據(jù)粉末燒結(jié)理論,由粉 末材料構(gòu)成的顆粒系統(tǒng)在燒結(jié)時(shí)傾向于降低其表 面的自由能,這是推進(jìn)燒結(jié)進(jìn)程的主要?jiǎng)恿Γ瑹Y(jié)頸的長(zhǎng)大是燒結(jié)過程進(jìn)行的具體表現(xiàn). 在燒結(jié)過程 中,首先分散/疏松的納米顆粒在壓力作用下相互接 觸,然后隨著溫度的升高發(fā)生表面擴(kuò)散、晶界擴(kuò)散、 晶內(nèi)擴(kuò)散,燒結(jié)頸逐漸長(zhǎng)大,組織趨于致密化. 燒結(jié)后的組織為多孔結(jié)構(gòu),與塊體材料相比具有更小的模量,更容易發(fā)生塑性變形,對(duì)粗糙、不平整表面有 優(yōu)異的“填補(bǔ)”效應(yīng) ,具有更寬的工藝窗口.
根據(jù)納米材料燒結(jié)前的形態(tài)進(jìn)行劃分,研究中 的 Cu 納米材料主要包括三類:納米線、納米多孔骨 架和納米顆粒. 下面分別對(duì)這三方面的研究現(xiàn)狀進(jìn)行簡(jiǎn)要介紹.
4.2 Cu 納米線燒結(jié)
Roustaie,Strahringer,Yu等人提出了 一種基于 Cu 納米線燒結(jié)的工藝,該工藝的優(yōu)勢(shì)主 要體現(xiàn)在其 Cu 納米線陣列的圖形化方式與成熟半 導(dǎo)體工藝良好兼容,可實(shí)現(xiàn)高密度 Cu 納米線凸點(diǎn) 的制備. 具體工藝流程如圖 18 所示:①在對(duì)晶圓進(jìn) 行厚膠光刻漏出 Cu 焊盤,Cu 焊盤作為納米線生長(zhǎng) 的基底,光刻膠作為納米線定向生長(zhǎng)的掩膜;②通 過氧等離子體轟擊去除 Cu 焊盤表面的有機(jī)物殘 留;③將帶有直孔陣列的特制掩模板壓覆在晶圓表 面,并與 Cu 焊盤接觸,整體浸沒到 Cu 電鍍液中;④隨后進(jìn)行電鍍工藝,電鍍過程中 Cu 納米線以 Cu 焊盤為基底,沿著掩模版孔陣列的方向向上生 長(zhǎng);(5) 最后去除掩模版,獲得由 Cu 納米線構(gòu)成的 凸點(diǎn)陣列.
這種方法可以實(shí)現(xiàn)凸點(diǎn)陣列的晶圓級(jí)制備,如 圖 19a,b 所示. 所獲得的 Cu 納米線陣列可以在 230 ℃,60 MPa 的溫度、壓力條件下實(shí)現(xiàn) 57.4 MPa 的剪切強(qiáng)度,且經(jīng)過 1 000 個(gè)熱循環(huán)測(cè)試 (?40 ~ 150 ℃) 和 4 000 h 的 HAST 測(cè)試 (85 ℃, 85% 濕 度) 后剪切強(qiáng)度無明顯下降.
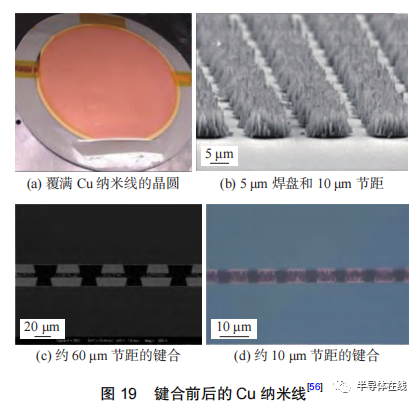
4.3 Cu 納米多孔骨架燒結(jié)
Shahane,Sosa,Mohan等人提出了 一種可圖形化的脫合金法制備 Cu 納米多孔骨架凸點(diǎn),其具體工藝流程如圖 20 所示. 首先在晶圓 表面濺射一層 Ti/Cu 作為后續(xù)電鍍工藝的種子層, 隨后旋涂光刻膠并進(jìn)行光刻得到所需的孔陣列圖案 ,接著在光刻膠孔內(nèi)分別電鍍 4 ~ 8 μm 厚的 Cu 凸點(diǎn)和 5 ~ 10 μm 厚的 Cu-Zn 合金,光刻膠去除 后即可得到上方為 Cu-Zn 合金、下方為 Cu 的復(fù)合 凸點(diǎn)結(jié)構(gòu),最后使用 1% 質(zhì)量分?jǐn)?shù)的 HCl 在室溫下 腐蝕 4 h 使得 Cu-Zn 合金中的 Zn 被腐蝕并獲得 Cu 納米多孔骨架凸點(diǎn).
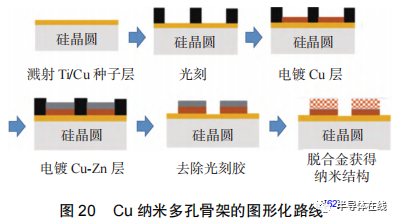
在 Cu 納米多孔骨架制備方面,研究人員主要 研究了電流密度、Cu-Zn 合金中 Zn 的含量、退火工 藝對(duì) Cu 納米多孔骨架組織的影響,結(jié)果表明在電 流密度為 2.75 mA/cm2 、Zn 含量為 85%、200 ℃/ 30 min/N2 退火的工藝條件下,可以獲得較理想的 納米多孔結(jié)構(gòu),如圖 21 所示,特征尺寸在 60 nm 以下,其中約有 10% 的 Zn 殘留.
在 250 ℃,9 MPa,30 min,5% 甲酸氣氛的鍵合 條件下,剪切強(qiáng)度可達(dá) 47 MPa. 如圖 22 所示,鍵合 前約 3 ~ 4 μm 厚的多孔納米結(jié)構(gòu)被壓縮到了 1 μm 以內(nèi),這表明該方法可以在一定程度上通過塑性變 形彌補(bǔ)基板翹曲以及 Cu 柱高度差帶來的不平整 度. 不過,該工藝制備獲得的 Cu 多孔結(jié)構(gòu)中存在 一定的 Zn 殘余,活潑金屬對(duì)長(zhǎng)期服役可靠性的影 響需要進(jìn)一步研究.
4.4 Cu 納米顆粒燒結(jié)
目前,Cu 納米顆粒用于燒結(jié)連接主要是通過 配置成銅納米焊膏并應(yīng)用于功率器件封裝. 如 圖 23 所示,功率器件封裝的芯片與基板間一般只 有一個(gè)互連層,而先進(jìn)封裝互連的焊點(diǎn)數(shù)量成千上 萬. Cu 納米焊膏應(yīng)用于先進(jìn)封裝互連的難點(diǎn)之一 是圖形化,即如何制作出大規(guī)模焊點(diǎn)陣列.
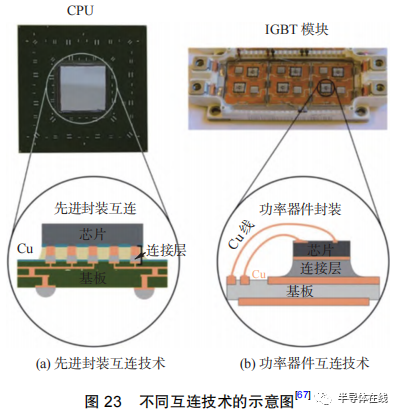
Del Carro,Zürcher等人提出了一種浸 蘸轉(zhuǎn)移的方法實(shí)現(xiàn)焊膏圖形化 ,其具體流程如 圖 24 所示. 首先將微納米顆粒混合的 Cu 焊膏通過刮刀刮平獲得約 20 μm厚度的薄層 ,將電鍍有 Cu 凸點(diǎn)的芯片在焊膏中浸蘸使得 Cu 凸點(diǎn)頂端黏附有 8 ~ 12 μm 厚度的 Cu 焊膏,接著將芯片與基板進(jìn)行 對(duì)中并在甲酸氣氛下 160 ~ 200 ℃ 燒結(jié)鍵合.
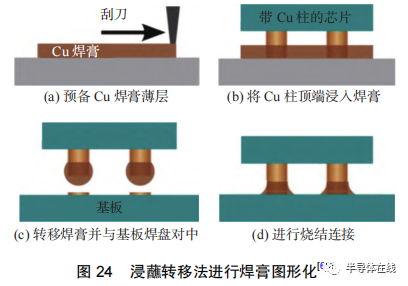
研究人員首先研究了 Cu 凸點(diǎn)的輪廓形態(tài)、浸 蘸轉(zhuǎn)移的速度、焊膏粘度等對(duì)圖形化的影響,結(jié)果 表明該方法具有良好的穩(wěn)定性,可以適應(yīng)一定的工 藝波動(dòng). 并重點(diǎn)分析了鍵合壓力對(duì)界面燒結(jié)組織 和性能的影響,結(jié)果如圖 25 所示. 從圖中可以看 到,鍵合壓力對(duì)燒結(jié)組織的孔隙率有明顯影響,無 壓燒結(jié)情況下燒結(jié)組織出現(xiàn)明顯的聚集性孔洞,可 靠性存在隱患,且剪切強(qiáng)度只有約 10 MPa;隨著壓 力增大到 50 MPa,界面組織趨于致密,剪切強(qiáng)度提 升至 40 MPa 左右. 該方法率先將 Cu 納米焊膏應(yīng) 用到先進(jìn)封裝互連領(lǐng)域,并表現(xiàn)出良好的適用性, 具有良好的應(yīng)用前景,但相關(guān)可靠性測(cè)試數(shù)據(jù)還比較少,需要進(jìn)一步研究. 此外,由于 Cu 納米焊膏具 有一定的流動(dòng)性,易在壓力作用下發(fā)生擠出從而導(dǎo) 致相鄰焊點(diǎn)“橋接”,所以該方法在實(shí)現(xiàn)窄節(jié)距互連 上面臨一定局限性.
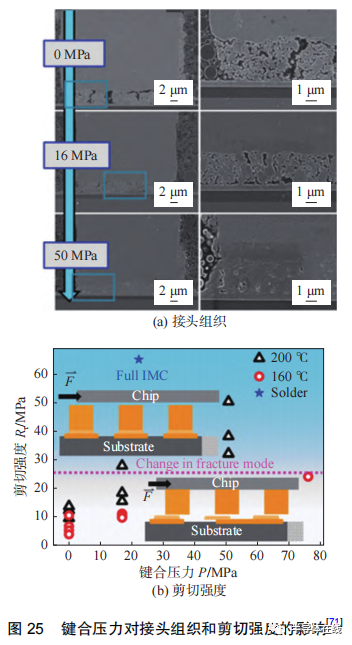
此外,Mimatsu 等人基于 Cu 納米顆粒粉末 提出了類似的轉(zhuǎn)移方法進(jìn)行圖形化. 研究人員將通 過化學(xué)法合成的 Au 納米顆粒粉末鋪勻到裸硅片 上,再將帶金凸點(diǎn)的芯片與裸硅片壓到一起并加熱 到 100 ℃,使得 Au 納米顆粒與金凸點(diǎn)表面發(fā)生一 定程度的預(yù)燒結(jié),最后將芯片與基板對(duì)中鍵合到一 起.這種方法最大的問題是納米顆粒粉末與凸點(diǎn)間 的結(jié)合很弱,部分凸點(diǎn)上沒有或只有很少的納米顆 粒附著.
清華大學(xué)鄒貴生團(tuán)隊(duì)最新提出了基于脈沖激 光沉積 (Pulsed Laser Deposition,PLD) 技術(shù)圖形化 制備 Cu 納米顆粒并用于 Cu-Cu 低溫鍵合的方法. 如圖 26 所示,該方法通過 PLD 沉積工藝制備出 Cu 納米顆粒,并以光刻膠作沉積掩膜,隨后剝離去 除光刻膠即可獲得由納米顆粒構(gòu)成的凸點(diǎn)陣列 (直 徑 60 μm、節(jié)距 120 μm). 在 250 ℃,9 MPa,10 min, 甲酸氣氛鍵合條件下,剪切強(qiáng)度達(dá) 52.2 MPa,鍵合 前高度約 10 μm 的凸點(diǎn)被壓縮至約 4 μm. 與具有 流動(dòng)性的納米焊膏相比,PLD 制備出的納米顆粒為全固態(tài)結(jié)構(gòu),因此加壓過程中不易出現(xiàn)溢出導(dǎo)致焊 點(diǎn)短路的問題. 此外,該方法制備出的凸點(diǎn)具有良 好的塑性變形能力和低溫互連性能.未來可繼續(xù)深 入對(duì)該方法的電學(xué)性能、服役可靠性等方面的研究.
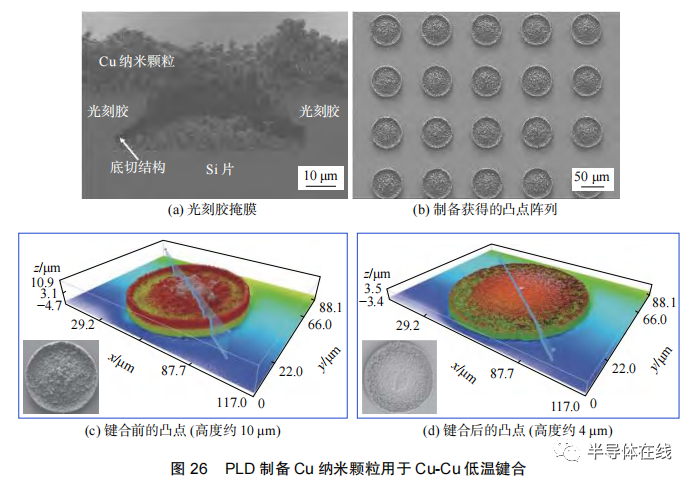
5 結(jié)論
(1) 隨著主流 Sn 基軟釬焊工藝逐漸無法滿足 未來先進(jìn)封裝互連的要求,Cu-Cu 鍵合技術(shù)憑借其 可實(shí)現(xiàn)窄節(jié)距、高性能互連且與半導(dǎo)體制造工藝兼 容性好等優(yōu)勢(shì)脫穎而出,成為先進(jìn)封裝互連的重要 發(fā)展方向.
(2) 為了降低 Cu-Cu 鍵合溫度,研究人員提出 了通過晶粒定向生長(zhǎng)、飛行切割、插入式互連結(jié)構(gòu) 等方法來提高 Cu 原子擴(kuò)散速率以及采用等離子體 轟擊、金屬或有機(jī)物作鈍化層來減少/防止 Cu 表面 氧化的方法.
(3) 混合鍵合在窄節(jié)距互連時(shí)將 Cu-Cu 及介 質(zhì)-介質(zhì)分別鍵合起來,鍵合后的介質(zhì)起到下填料的 作用,具有更優(yōu)的熱/機(jī)械可靠性. 混合鍵合包括 Cu/SiO2、Cu/粘結(jié)劑鍵合兩類,鍵合時(shí)工藝要綜合 考慮 Cu-Cu 鍵合及介質(zhì)-介質(zhì)鍵合兩方面.
(4) 熱壓鍵合和混合鍵合對(duì)待鍵合表面的粗糙 度、光潔度、晶圓翹曲程度等有嚴(yán)格要求,往往需要 昂貴、復(fù)雜的平坦化工藝及較高的鍵合壓力來保證 鍵合表面充分接觸. 此外,混合鍵合技術(shù)在應(yīng)用于 2.5D 互連時(shí)也面臨一定挑戰(zhàn).
(5) 近年來,基于納米材料燒結(jié)實(shí)現(xiàn) Cu-Cu 低 溫鍵合逐步獲得關(guān)注. 納米材料具有低溫連接、界 面填縫等優(yōu)勢(shì),可降低工藝要求. 研究人員采用定 向生長(zhǎng)納米線、脫合金制備納米多孔骨架、浸蘸轉(zhuǎn) 移納米焊膏、PLD 沉積納米顆粒等方法分別實(shí)現(xiàn)了 焊點(diǎn)圖形化和 Cu-Cu 低溫鍵合,并在降低鍵合溫 度、壓力、適應(yīng)基板翹曲等方面表現(xiàn)出一定潛力,但 仍需要更多的性能、可靠性測(cè)試作支撐. 目前納米 材料燒結(jié)連接應(yīng)用于 Cu-Cu 鍵合的研究還處于起 步階段,未來繼續(xù)開發(fā)出寬工藝冗余、窄節(jié)距圖形 化、優(yōu)良互連性能的納米材料互連方式仍大有可為.
-End-*博客內(nèi)容為網(wǎng)友個(gè)人發(fā)布,僅代表博主個(gè)人觀點(diǎn),如有侵權(quán)請(qǐng)聯(lián)系工作人員刪除。


