動(dòng)向 | 瞄準(zhǔn)臺(tái)積電!三星首秀3D 封裝技術(shù),可用于7納米制程
三星官網(wǎng)13日新聞稿稱,三星3D IC封裝技術(shù)X-Cube,采用硅穿孔科技(through-silicon Via,TSV),能讓速度和能效大躍進(jìn),以協(xié)助解決新一代應(yīng)用程式嚴(yán)苛的表現(xiàn)需求,如5G、人工智能(AI)、高性能運(yùn)算、移動(dòng)和可穿戴裝置等。
三星晶圓代工市場(chǎng)策略的資深副總Moonsoo Kang 說(shuō):「三星的新3D 整合技術(shù),確保TSV 在先進(jìn)的極紫外光(EUV)制程節(jié)點(diǎn)時(shí),也能穩(wěn)定聯(lián)通」。有了X-Cube,IC 設(shè)計(jì)師打造符合自身需求的客制化解決方案時(shí),將有更多彈性。X-Cube 的測(cè)試芯片,以7 納米制程為基礎(chǔ),使用TSV 技術(shù)在邏輯晶粒(logic die)堆疊SRAM,可釋放更多空間、塞入更多存儲(chǔ)器。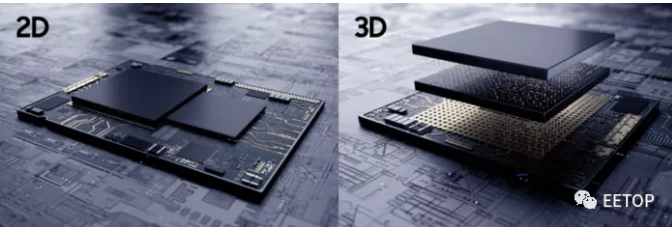
有了3D整合方案,晶粒間的訊號(hào)傳輸路徑將大為縮短,可加快數(shù)據(jù)傳送速度和能源效益。三星宣稱,X-Cube可用于7納米和5納米制程。
韓國(guó)時(shí)報(bào)13 日?qǐng)?bào)導(dǎo),封裝是晶圓生產(chǎn)的重要環(huán)節(jié),過(guò)去幾年來(lái),三星強(qiáng)化封裝技術(shù),超薄封裝能縮短積體電路的訊號(hào)傳輸路徑,加快傳遞速度、提升能源效益。三星將在16~18 日的Hot Chips 峰會(huì),公布更多X-Cube 的細(xì)節(jié)。
*博客內(nèi)容為網(wǎng)友個(gè)人發(fā)布,僅代表博主個(gè)人觀點(diǎn),如有侵權(quán)請(qǐng)聯(lián)系工作人員刪除。