倒裝芯片封裝更具競爭力
隨著倒裝芯片封裝在成本和性能上的不斷改進,加上鍵合金線價格的不斷攀升,從手機到游戲機芯片的各種應用領域里,倒裝芯片技術都變得更具競爭力。
回首15年前,幾乎所有封裝采用的都是引線鍵合。如今倒裝芯片技術正在逐步取代引線鍵合的位置。倒裝芯片的基本概念就是拿來一顆芯片,在連接點位置放上導電的凸點,將該面翻轉,有源面直接與電路相連接。倒裝芯片避免了多余的封裝工藝,同時得到像縮小尺寸、可高頻運行、低寄生效應和高I/O密度的優點(圖1)。
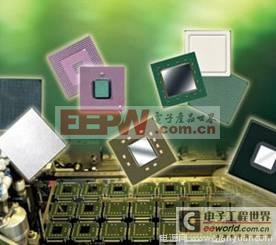
在從手機和尋呼機到MP3播放器和數碼相機的所有熱門的消費類電子產品中,幾乎都能找到倒裝芯片封裝。在服務器中,近乎所有的邏輯模塊都采用倒裝芯片封裝。大部分ASIC、游戲機電路、圖形處理器、芯片組、現場可編程門陣列(FPGA)和數字信號處理器(DSP)也都已采用了倒裝芯片封裝(圖2)。
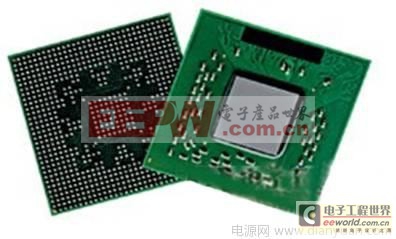
圖1. 像這個倒裝芯片BGA系統級封裝(SiP)的應用那樣,隨著金線鍵合成本的提升,對倒裝芯片的需求在不斷增加。(來源: STATS ChipPAC)
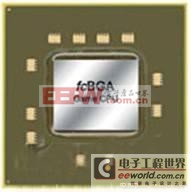
圖2. 為游戲機CPU設計的倒裝芯片BGA。(來源:Amkor)
在過去幾年里金絲引線鍵合的成本不斷提高——這使得倒裝芯片變得更具吸引力。“如果看一下兩到三年前的成本,自然而然是倒裝芯片更高,” STATS ChipPAC(新加坡)負責倒裝芯片和新興產品的副總裁Raj Pendse這樣介紹。“通常來說倒裝芯片所用的封裝基板成本是引線鍵合襯底的兩到三倍,但金價的飆升卻超過了封裝基板的差價。在很寬泛的應用領域里,倒裝芯片已經成了更具成本效益的解決方案。過去兩種方法的成本平衡點是1000引腳。現在只要在200到700引腳范圍內,倒裝芯片就更劃算。”
倒裝芯片的歷史回顧
倒裝芯片技術的首次應用可以追溯到1964年。根據IBM封裝技術戰略部門的杰出工程師Peter Brofman介紹,那時他們已經在IBM S/360大型機中采用了混合固態邏輯技術(SLT)。這一技術主要是采用一些大節距的銅珠用作額外支撐,可以防止與無源器件之間的短路。“真正將倒裝芯片用在IC中始于1969年,但當時只有四邊引腳的方案,”他解釋說。“完全面陣列的金屬化陶瓷(MC)技術出現在70年代中期。在80年代早期,IBM已經可以完成11×11陣列、節距為250 μm的Pb-5Sn焊料球了。 ”
80年代末和90年代初,摩托羅拉從IBM獲得倒裝芯片的授權,開始尋找倒裝芯片陶瓷載體的替代物,開啟了對芯片到載體的下填充物以及低成本FR4有機材料的研究。IBM封裝工程經理Patrick OLeary指出,這些工作是與卡上加層的技術并行開發的,這一技術基于1990年的表面多層電路(SLC)工藝,到90年代中期,多芯片載體已經相當普遍。
“到1998年,大尺寸的微處理器開始采用芯片下填充料,并且轉向有機倒裝芯片加強載體,2000到2001年,35 mm、2-2-2載體基板的價格已經接近3美元,”O’Leary介紹說。“同引線鍵合相比,倒裝芯片仍‘有點貴’,但性價比已經很高,因此圖形處理器和游戲機處理器先后從倒裝芯片技術中獲益,到04、05年左右,已經完成了向有機倒裝芯片模塊的轉移。”
IBM已經將所有新的倒裝芯片單芯片模塊(SCM)轉向多層載體基板。O’Leary指出,處理器向倒裝芯片的重大轉移使得倒裝芯片模塊的年復合增長率(CAGR)比十年前提高了35%。“現在CAGR雖然低了一些,但仍然強勁,隨著金價的上揚,兩種方法的成本平衡點已經降到了200-700 I/O。在更低的引腳數下,整合器件制造商(IDM)將在他們的封裝方案中淘汰引線鍵合——很可能從32 nm節點開始。”
最近,倒裝芯片領域其他的里程碑還包括倒裝芯片的“凸點工藝”,或者說焊料沉積可選范圍的發展。90年代中期,像300 mm這樣的大尺寸晶圓驅使IBM和其他廠商從真空蒸發方法轉向電鍍方法。最近IBM和SUSS MicroTec(德國慕尼黑)共同開發并商業化了IBM的下一代無鉛半導體封裝技術,也就是可控塌陷芯片連接新工藝(C4NP),目前已進入量產。O’Leary指出,采用C4NP可以在前端就完成預先圖形化的焊料球,縮短了工藝流程的時間。可以預先檢查焊料凸點,并采用與晶圓級鍵合類似的技術,一步沉積在晶圓上。這種方法將焊料涂覆的簡便性(網版/絲印)和電鍍的窄節距能力結合在一起。“C4NP和電鍍方法都可以在產品中獲得150 μm的C4節距,從而滿足硅器件等比例縮減的要求,”O’Leary介紹說。 function ImgZoom(Id)//重新設置圖片大小 防止撐破表格 { var w = $(Id).width; var m = 650; if(w
盡管當初IBM開發倒裝芯片技術是為了滿足大型計算機市場的要求,但倒裝芯片的應用范圍已經遠遠超出了計算機,Amkor(亞利桑那州,Chandler)負責倒裝芯片的高級主管Frederick Hamilton說。“倒裝芯片已經進入到計算機、無線通信、網絡、電信/數據、汽車和消費類電子(HDTV)市場,”他表示。“但PC仍然是半導體和倒裝芯片器件的最大單一用戶。”
有意思的是,倒裝芯片的平均現場壽命大約為15年——盡管部分產品的設計壽命是5年。Pendse還指出:“考慮到倒裝芯片的基本結構,很輕松地就可達到15年的現場壽命。”
關鍵的技術優勢
倒裝芯片的主要優勢包括可縮減和節省空間,此外還有互連通路更短且電感更低、高I/O密度、返工和自對準能力。對散熱管理來說,倒裝芯片的性能也很突出。
倒裝芯片可以采用面陣列互連,這意味著比四周排列封裝更高的I/O密度和更有效的電源供應。“如果需要的話,你可以將電源直接供應到芯片中間位置去。這有很大的優點。對RF和其他一些應用來說,倒裝芯片帶來的低寄生效應非常重要,”Pendse說。“另一個優點是因為芯片是與基板直接連接的,你就不需要扇出了——這與需要芯片到基板I/O扇出的引線鍵合不同。它意味著你可以獲得尺寸更小的封裝。”



評論