高端準諧振零壓開關反激式轉換器中的ESBT技術
發射極開關(Emitter Switching)研究的目的是在開關損耗和傳導損耗之間找到最佳平衡點(主要是高壓應用)。發射極開關的主要結構包括一個高壓功率雙極晶體管以及驅動這個雙極管的低壓功率MOSFET晶體管。這兩個晶體管串聯在一起,如圖1所示。這個結構需要兩個電源:第一個電源給功率雙極晶體管的基極供應電流,第二個電源供給功率MOSFET的柵極。雖然功率雙極晶體管的基極不需要適當的驅動電路,但是使功率雙極晶體管飽和還需要給基極施加適當的偏壓,所以主要的傳導損耗是VCE(sat)損耗與功率雙極晶體管輸入損耗之和。
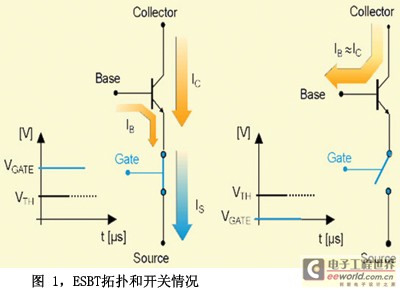
如果關閉功率MOSFET晶體管的電源,泄漏電流會立即降至零,這樣輸出電流就會通過晶體管的基極將電流通路改為接地,這個過程持續到所有少數載流子全都移出這個區域而且雙極晶體管結構自動關斷為止。這個關斷特性導致基極內貯存的電荷被快速移除,從而降低了貯存時間,最重要的是,這種結構基本上沒有雙極晶體管固有的尾電流特性。這種配置通過提高二次側抗擊穿電壓的能力,擴大了反向工作區的安全極限。事實上,因為發射極是開路,在發射極下幾乎不存在電流阻塞現象(電流阻塞可能會導致熱點)。
如圖2所示,發射極和基極區分別使用了兩個埋層。事實上,因為BJT晶體管的發射極恰好與低壓功率MOSFET晶體管的漏極位于同一區域,要想BJT實現所需的電流能力和增益,要想功率MOSFET晶體管實現所需的擊穿電壓,就必須對埋層進行合理選擇。因此在高阻率的埋層上擴散一個DMOS結構,覆蓋高度摻雜的發射極區域(N-BL)。從擴散層和沉積層角度看,即便DMOS結構的布局與雙極晶體管的發射極幾何形狀匹配,DMOS結構也與一個標準低壓功率MOSET晶體管的結構十分類似。最后,把基極觸點放置在擴散層上,深度需達到基極埋層(P-BL)。需要指出的是,基極觸點下面的P阱區與集成的DMOS共同構成一個多余的橫向寄生絕緣柵雙極晶體管IGBT。事實上,因為發射極開關配置的特性(基極總是被施加一個恒壓),這個IGBT總是導通狀態,因此,大大降低了ESBT的電流處理性能。為了防止這種有害現象,需要增加一個摻雜度、尺寸和距DMOS距離適中的深阱。
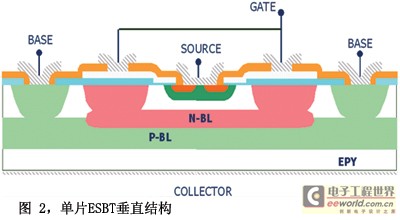
準諧振反激式拓撲和用ESBT實現的應用
在高端工業應用領域取得成功后,我們將ESBT的研發重點轉向低端應用,如筆記本電腦適配器、打印機電源和液晶電視的開關電源。采用反激式變換器在QR(準諧振模式下)工作是提高能效的最主要和最簡單的方法之一。QR反激式轉換器是變頻式標準反激式轉換器。采用這種拓撲有幾個優點:QR方法利用本來有害的寄生漏電容產生一個將開關的導通損耗降至最低限度的零壓條件。
變頻操作是這種功能固有的。主要優點與傳導的EMI有關。簡單地說,QR反激式結構的工作原理是進行所謂的谷值開關,即在磁芯退磁后發生諧振期間內在最低電壓下導通。根據方程式Eon= CV2計算導通損耗,其V是導通電壓,C是寄生電容。最好是開關在零壓下導通。只要選擇反激電壓等于輸入電壓即可實現零壓開關。然而這種配置會給芯片帶來很大的電壓應力,對于一個正常的離線轉換器,在變壓器正常泄漏電感條件下,這個電壓可達到1200V(如果沒有箝位電路)。無論額定電壓和電流如何,ESBT的電壓降都很低,而且開關性能十分優異,所以ESBT是成本效益最高的轉換器解決方案。
我們對一個180W、19V單輸出適配器進行了重新設計,把主開關的600W功率MOSFET晶體管改成1200V的ESBT晶體管,并去除了原設計中的箝位網絡。功率MOSFET電壓應力遠遠高于額定擊穿電壓,因此可能會產生雪崩和不安全的工作狀況。選擇600V擊穿電壓是因為需要極低的RDS(on)(高能效)。為了證明使用ESBT后能夠達到更高的性能和安全性,我們去除了箝位網絡,并增加了基極驅動網絡。在這種情況下,因為峰壓是900V,所以一個1200V的ESBT就夠用了。在正常工作條件下,ESBT的外殼溫度達到48℃。測試結果證明低VCE(sat)和高速開關性能將功耗降低6W,把總能效提高3%。
進一步改進方案
經過重新設計變壓器,提高反激電壓,可以進一步改進設計。在后一個案例中,使用一個1.5kV的ESBT,功率開關可以承受1300V的超高電壓應力。在后一個案例分析中,如果采用相同的散熱器,ESBT的工作溫度比任何其它情況都低(42℃)。因為匝比發生變化,轉換器二次側的應力被大幅度降低,因為使用了同步整流電路,所以可以用一個價格更低的性能更高的60V場效應晶體管替代100V的場效應晶體管。
發射極開關(Emitter Switching)研究的目的是在開關損耗和傳導損耗之間找到最佳平衡點(主要是高壓應用)。發射極開關的主要結構包括一個高壓功率雙極晶體管以及驅動這個雙極管的低壓功率MOSFET晶體管。這兩個晶體管串聯在一起,如圖1所示。這個結構需要兩個電源:第一個電源給功率雙極晶體管的基極供應電流,第二個電源供給功率MOSFET的柵極。雖然功率雙極晶體管的基極不需要適當的驅動電路,但是使功率雙極晶體管飽和還需要給基極施加適當的偏壓,所以主要的傳導損耗是VCE(sat)損耗與功率雙極晶體管輸入損耗之和。
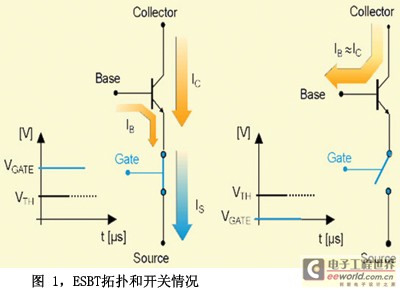
如果關閉功率MOSFET晶體管的電源,泄漏電流會立即降至零,這樣輸出電流就會通過晶體管的基極將電流通路改為接地,這個過程持續到所有少數載流子全都移出這個區域而且雙極晶體管結構自動關斷為止。這個關斷特性導致基極內貯存的電荷被快速移除,從而降低了貯存時間,最重要的是,這種結構基本上沒有雙極晶體管固有的尾電流特性。這種配置通過提高二次側抗擊穿電壓的能力,擴大了反向工作區的安全極限。事實上,因為發射極是開路,在發射極下幾乎不存在電流阻塞現象(電流阻塞可能會導致熱點)。
如圖2所示,發射極和基極區分別使用了兩個埋層。事實上,因為BJT晶體管的發射極恰好與低壓功率MOSFET晶體管的漏極位于同一區域,要想BJT實現所需的電流能力和增益,要想功率MOSFET晶體管實現所需的擊穿電壓,就必須對埋層進行合理選擇。因此在高阻率的埋層上擴散一個DMOS結構,覆蓋高度摻雜的發射極區域(N-BL)。從擴散層和沉積層角度看,即便DMOS結構的布局與雙極晶體管的發射極幾何形狀匹配,DMOS結構也與一個標準低壓功率MOSET晶體管的結構十分類似。最后,把基極觸點放置在擴散層上,深度需達到基極埋層(P-BL)。需要指出的是,基極觸點下面的P阱區與集成的DMOS共同構成一個多余的橫向寄生絕緣柵雙極晶體管IGBT。事實上,因為發射極開關配置的特性(基極總是被施加一個恒壓),這個IGBT總是導通狀態,因此,大大降低了ESBT的電流處理性能。為了防止這種有害現象,需要增加一個摻雜度、尺寸和距DMOS距離適中的深阱。
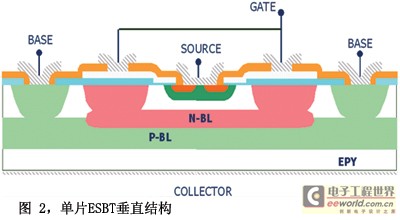
準諧振反激式拓撲和用ESBT實現的應用
在高端工業應用領域取得成功后,我們將ESBT的研發重點轉向低端應用,如筆記本電腦適配器、打印機電源和液晶電視的開關電源。采用反激式變換器在QR(準諧振模式下)工作是提高能效的最主要和最簡單的方法之一。QR反激式轉換器是變頻式標準反激式轉換器。采用這種拓撲有幾個優點:QR方法利用本來有害的寄生漏電容產生一個將開關的導通損耗降至最低限度的零壓條件。
變頻操作是這種功能固有的。主要優點與傳導的EMI有關。簡單地說,QR反激式結構的工作原理是進行所謂的谷值開關,即在磁芯退磁后發生諧振期間內在最低電壓下導通。根據方程式Eon= CV2計算導通損耗,其V是導通電壓,C是寄生電容。最好是開關在零壓下導通。只要選擇反激電壓等于輸入電壓即可實現零壓開關。然而這種配置會給芯片帶來很大的電壓應力,對于一個正常的離線轉換器,在變壓器正常泄漏電感條件下,這個電壓可達到1200V(如果沒有箝位電路)。無論額定電壓和電流如何,ESBT的電壓降都很低,而且開關性能十分優異,所以ESBT是成本效益最高的轉換器解決方案。
我們對一個180W、19V單輸出適配器進行了重新設計,把主開關的600W功率MOSFET晶體管改成1200V的ESBT晶體管,并去除了原設計中的箝位網絡。功率MOSFET電壓應力遠遠高于額定擊穿電壓,因此可能會產生雪崩和不安全的工作狀況。選擇600V擊穿電壓是因為需要極低的RDS(on)(高能效)。為了證明使用ESBT后能夠達到更高的性能和安全性,我們去除了箝位網絡,并增加了基極驅動網絡。在這種情況下,因為峰壓是900V,所以一個1200V的ESBT就夠用了。在正常工作條件下,ESBT的外殼溫度達到48℃。測試結果證明低VCE(sat)和高速開關性能將功耗降低6W,把總能效提高3%。



評論