基于Icepak的放大器芯片熱設(shè)計與優(yōu)化
摘要:針對微波電路A類放大器常用的功率放大器芯片,建立了芯片內(nèi)部封裝后的散熱模型。基于熱阻理論,在對放大器芯片等效熱阻做熱分析的基礎(chǔ)上,采用Icepak對影響芯片散熱的焊料層、墊盤、基板的材料和厚度進(jìn)行優(yōu)化,分析各個變量對芯片溫度造成的影響,最后給出了高可靠性的芯片熱設(shè)計結(jié)果。
本文引用地址:http://www.104case.com/article/201610/307093.htm關(guān)鍵詞:熱設(shè)計;功率芯片;Icepak;優(yōu)化
在微波放大電路中,功率芯片是整個電路最為核心的部分。芯片中大量的半導(dǎo)體器件在工作時會產(chǎn)生大量的熱量。芯片如果在封裝過程中散熱效率達(dá)不到要求的話,積累的熱量會影響器件特性,甚至是毀壞器件造成電路失去功能。為了提高芯片的可靠性,必須進(jìn)行熱分析與熱控制。Icepak作為一款專業(yè)的熱分析軟件,提供了系統(tǒng)級、板級到器件級不同類型的熱分析平臺,其求解過程基于fluent求解器,可以計算穩(wěn)態(tài)和瞬態(tài)不同的過程。強(qiáng)大的后處理可以用云圖直觀地輸出各個參量。相對于傳統(tǒng)的熱設(shè)計方案,基于Icepak的仿真優(yōu)化設(shè)計方法可以節(jié)約成本和縮短研制修改周期,提高產(chǎn)品的一次成功率和提前上市時間。
文中在介紹熱阻理論的基礎(chǔ)上,詳細(xì)地介紹了Icepak軟件建模、網(wǎng)格劃分、求解和后處理的過程。收集整理了改變焊層、墊板和基板的材料和厚度時芯片最高溫度并分析原因,總結(jié)并給出最優(yōu)化的熱設(shè)計結(jié)果。
1 典型功率芯片封裝結(jié)構(gòu)和等效熱阻模型
熱流自芯片流向外部環(huán)境所受到阻礙稱為熱阻。也指1 W功率在傳熱路徑上產(chǎn)生的溫度差,其表達(dá)是表示為:
R=△T/P (1)
對于熱導(dǎo)率為K,厚度為h,橫截面積為S的物體熱阻:
R=h/(K*S) (2)
圖1是此功率芯片封裝和散熱結(jié)構(gòu)示意圖。芯片成品封裝以后,芯片、墊板、基板和殼體通過焊料緊密連接在一起。半導(dǎo)體裸芯片滿負(fù)荷工作時的內(nèi)熱阻Rjc可以由生產(chǎn)商提供的手冊查到,本文主要通過改變焊料、墊盤和基板的材料和厚度進(jìn)行優(yōu)化,減小芯片的外部熱阻Rout使得芯片可以適應(yīng)更加復(fù)雜的熱環(huán)境,以達(dá)到結(jié)構(gòu)和工藝最優(yōu)化的目的。

對流和輻射對于芯片產(chǎn)生的熱量散熱貢獻(xiàn)很小,所以優(yōu)化過程中我們只考慮熱傳導(dǎo)過程。芯片的邊長為11,焊料層厚度為h1,墊盤厚度為h2,基板厚度為h3,由于厚度相比與橫截面尺寸很小,我們?nèi)「鲗拥纳媳砻婷娣e作為截面面積來計算熱阻。根據(jù)式(2)我們可以得到從第一層焊料到基板底部焊料層的熱阻為:

K1、K2、K3分別是焊料、墊盤和基板的導(dǎo)熱系數(shù)。
由公式(3)我們可以得到在更換不同導(dǎo)熱系數(shù)的材料和更改各層材料的厚度時候,都會對熱阻產(chǎn)生影響。而通過優(yōu)化使熱阻達(dá)到最小可以令芯片在更高的環(huán)境溫度下正常工作正是我們的目的。傳統(tǒng)理論計算優(yōu)化方法在面對復(fù)雜模型時工作量十分巨大,故本文采用ANAYS公司的Icepak軟件作為優(yōu)化設(shè)計工具。
2 Icepak建模
Icepak是專業(yè)的熱設(shè)計軟件,該軟件提供了豐富的模型和材料庫。并支持使用者新建材料。其提供的多變量優(yōu)化計算可以對存在多個變量的模型自動優(yōu)化,并可以定義多種輸出函數(shù)來輸出想要的結(jié)果。
圖2是根據(jù)表1在Icepak中建立的簡化模型并進(jìn)行網(wǎng)格劃分。由于芯片厚度Y遠(yuǎn)小于其X尺寸,所以在Y方向最小網(wǎng)格邊長是X方向上的十分之一。

3 計算與優(yōu)化
表格2給出了各個結(jié)構(gòu)常用的材料和導(dǎo)熱率。芯片熱參數(shù)如下:焊料為鉛錫合金,墊盤為鉬銅合金,基板為鋁硅碳材料。額定功率為4.5 W,內(nèi)部熱阻為7.8℃/W,芯片限制工作溫度為150℃,所以外部熱阻與芯片接觸面允許達(dá)到的最高溫度為:
Tcmax=150℃-7.8℃/W×4.5 W=114.9 ℃
保持焊料、墊盤和基板水平方向尺寸不發(fā)生變化,在工作環(huán)境為70℃時,通過改變厚度和材料時,Icepak優(yōu)化計算結(jié)果整理如下:
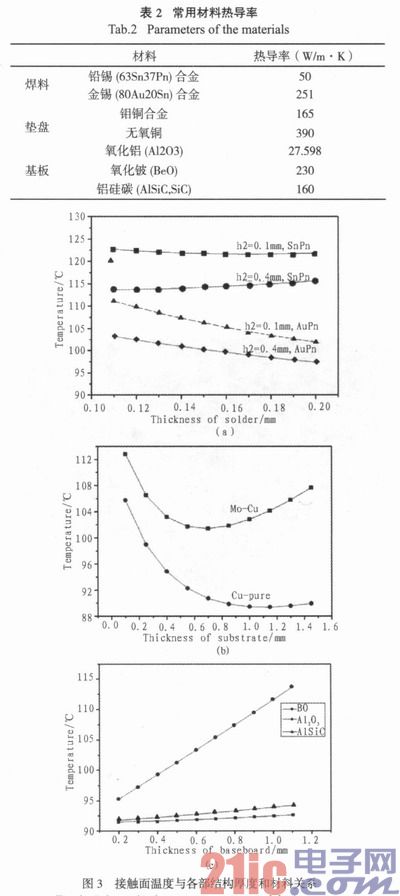
由圖3(a)可知,對于金錫合金焊料,芯片溫度隨著焊料層厚度增加而降低,對于鉛錫焊料,芯片溫度隨著焊料厚度增加增加。而且當(dāng)鉛錫焊料層厚度為0.1 mm時,芯片與接觸免處溫度超過115℃,相同情況采用金錫焊料芯片溫度可以降低20℃;圖3(b)指出其它條件不變時,溫度隨純銅墊盤厚度增加而降低,銅片厚度為0.1 mm時,最低點(diǎn)為89 ℃,采用鉬銅合金墊盤時溫度隨著鉬銅厚度呈現(xiàn)先降低后升高的
情況,在鉬銅厚度為0.7 mm,芯片有最低溫度102℃;圖3(b)可知芯片溫度隨著底板厚度增加溫度呈上升趨勢,不同類型底板上升速度不同,氧化鋁型底板上升最快,鋁硅碳其次,氧化鋇型最慢。
4 優(yōu)化結(jié)果
針對環(huán)境溫度70℃惡劣工作條件,在保持原有放大器芯片水平尺寸不變時,IceDak通過優(yōu)化焊料、墊盤和底板3個變量的厚度和材料得出了如下最優(yōu)化結(jié)構(gòu)。

圖4指出在金錫焊料層厚為0.1 mm,純銅墊盤厚度為0.8mm,底板厚度為0.5 mm時,芯片最高溫度為87℃,與臨界溫度105℃還相差較大,芯片可在此溫度高穩(wěn)定性工作。
5 結(jié)束語
本次優(yōu)化設(shè)計采用Icepak,在設(shè)定變量焊料、墊盤和底板的材料和變化范圍之后,Icepak自動進(jìn)行優(yōu)化并保存了所有的計算結(jié)果,最后給出可以使芯片具有最低溫度的結(jié)果。與以往芯片優(yōu)化方法相比更智能,優(yōu)化結(jié)果對于芯片封裝廠商生產(chǎn)高性能芯片具有參考價值。



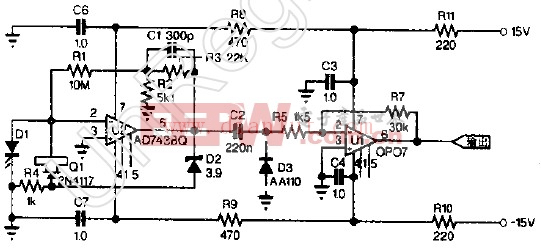
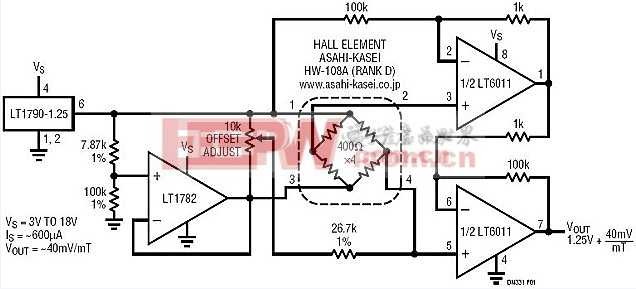

評論