一種減少VDMOS寄生電容的新結(jié)構(gòu)
VDMOS與雙極晶體管相比,它的開關(guān)速度快,開關(guān)損耗小,輸入電阻高,驅(qū)動電流小,頻率特性好,跨導(dǎo)高度線性等優(yōu)點(diǎn)。特別值得指出的是,它具有負(fù)溫度系數(shù),沒有雙極功率管的二次擊穿問題,安全工作區(qū)大。因此,不論是開關(guān)應(yīng)用還是線性應(yīng)用,VDMOS都是理想的功率器件。VDMOS的開關(guān)速度是在高頻應(yīng)用時的一個重要的參數(shù),因此提出一種減小寄生電容的新型VDMOS結(jié)構(gòu)。
1 基本原理
功率VDMOS的開關(guān)特性是由其本征電容和寄生電容來決定的。VDMOS的電容主要由三個部分柵源電容Cgs柵漏電容Cgd以及源漏電容Cds組成,如圖1所示。電容的充放電是限制其開關(guān)速度的主要因素。柵源之間的電容是由三個部分組成,即:
Cgs=Cgs(N+)+Cgs(P)+Cgs(M)
Cgs(N+)是柵源交疊電容;Cgs(M)是柵與源金屬間的電容;Cgs(P)是柵與P-base之間的電容。這三個電容的大小都是由VDMOS本身設(shè)計上的參數(shù)決定的,最主要取決于介質(zhì)層的厚度。
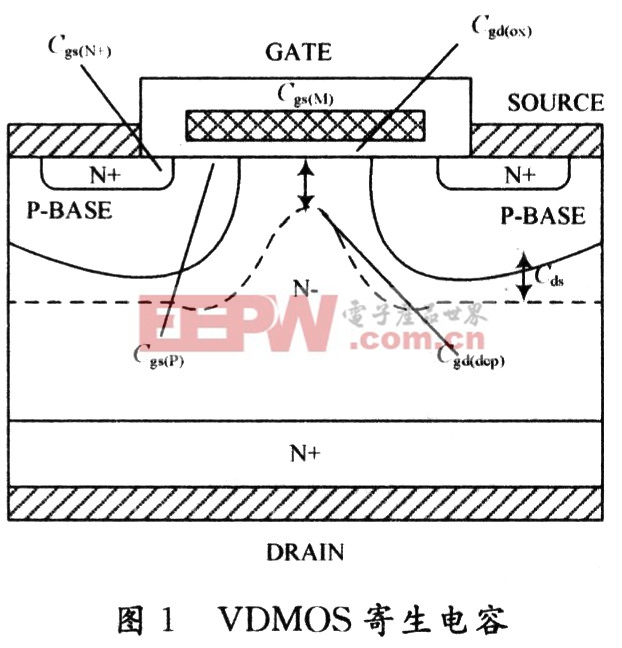
柵漏之間的電容Cgd是兩個電容的串聯(lián):
![]()
當(dāng)柵壓未達(dá)到閾值電壓時,漂移區(qū)與P-base形成的耗盡層結(jié)合在一起,形成面積很大的耗盡層電容,柵下漂移區(qū)空間電荷耗盡區(qū)電容Cgd(dep)只是其中一部分,此時耗盡層寬度最大,耗盡電容最小。當(dāng)柵壓達(dá)到閾值電壓后,器件開啟時,漏區(qū)電勢降低,耗盡層寬度減小,Cgd(dep)迅速增大。
漏源之間的電容Cds是一個PN結(jié)電容,它的大小是由器件在源漏之間所加的電壓VDS所決定的。
一般VDMOS都包含了Cgs,Cgd和Cds,但是功率VDMOS都不是采用這三個電容作參考,而是采用Ciss,Coss和Crss作為評估VDMOS器件的電容性能,Ciss,Coss和Crss參數(shù)分別定義為:輸入電容:Ciss=Cgs+Cgd輸出電容:Coss=Cds+Cgd;反饋電容:Crss=Cgd。實(shí)際中采用Ciss,Coss和Crss作為衡量VDMOS器件頻率特性的參數(shù),它們并不是定值,而是隨著其外部施加給器件本身的電壓變化的。
VDMOS的開啟延遲時間td(on)、上升時間tr、關(guān)斷延遲時間td(off)、下降時間tf的關(guān)系式可分別表達(dá)為:

式中:Rg為開關(guān)測試電路中器件外接?xùn)烹娮瑁籚th為閾值電壓;Vgs是外加?xùn)旁措妷海籿gs是使器件漏源電壓下降到外加值10%時的柵源電壓;Ciss*是器件的輸入電容;在td(on)和td(off)式中:Ciss*=Cgs+Cgd;在tr和tf式中:Ciss*=Cgs+(1+k)Cgd(考慮密勒效應(yīng))。由上述關(guān)系式可見,Cgd直接影響器件的輸入電容和開關(guān)時間,Cgd通過密勒效應(yīng)使輸入電容增大,從而使器件上升時間tr和下降tf時間變大,因此減小柵漏電容Cgd尤為重要。
2 新結(jié)構(gòu)的提出
根據(jù)上面對VDMOS電容的分析,提出一種新的結(jié)構(gòu)以減少器件的寄生電容。由分析可得出,柵下耗盡層的形狀對VDMOS電容有較大影響,最主要影響Cgd。
圖2中給出了新的VDMOS單元A,在VDMOSneck區(qū)域斷開多晶硅條,同時在斷開處注入一定的P型區(qū),改變VDMOS柵下耗盡區(qū)的形狀。這種新結(jié)構(gòu),在一定程度上加大耗盡區(qū)的寬度,從而減小Cgd。如圖2結(jié)構(gòu)中Pody下P-區(qū)注入?yún)^(qū)域?yàn)閚eck區(qū)中間3μm,注入能量是40 keV,注入劑量是1e13―3 cm,傳統(tǒng)結(jié)構(gòu)多晶硅柵完全覆蓋P-body島間漂移區(qū),正是由多晶硅柵和漂移區(qū)的交疊形成的柵漏電容在充電時需大量電荷,導(dǎo)致器件開關(guān)損耗很大,新結(jié)構(gòu)將多晶柵和漂移區(qū)的交疊部分移除,可以大大降低柵電荷,提高器件的動態(tài)性能。





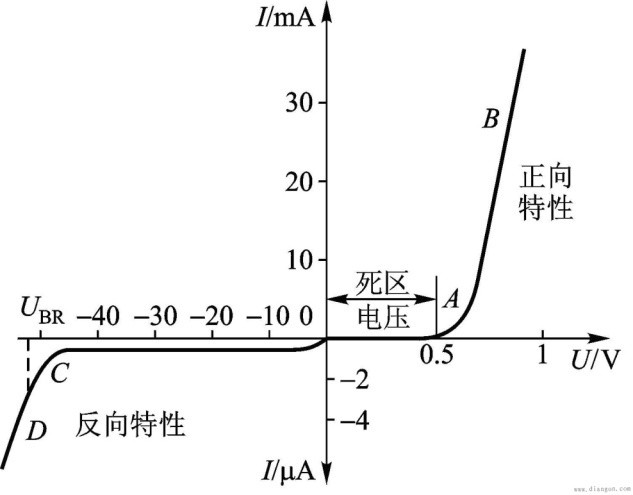




評論