一種200V/100A VDMOS 器件開發
3 工藝流水
根據揚州國宇電子有限公司現有多晶硅柵自對準工藝,制定了如下工藝流程:
備片→薄氧氧化→ SiN 淀積→一次光刻→刻蝕→場氧化→ SiN 剝離→柵氧氧化→多晶硅淀積→ 多晶硅摻雜→二次光刻→多晶硅刻蝕→中劑量硼(P-)注入→三次光刻→大劑量硼(P+)注入→ P 阱推進→四次光刻→大劑量磷(N+)注入→PSG淀積→PSG致密→五次光刻→接觸孔刻蝕→金屬化→ 六次光刻→金屬刻蝕→合金→鈍化介質淀積→七次光刻→刻蝕→原片減薄→背面金屬化→測試上述流程中,柵氧化、第三、四、五次光刻與第二次光刻套準、多晶硅刻蝕、P 阱推進等為關鍵工藝,需要重點監控,其余工藝均相對成熟。
表1 柵氧化工藝條件

3.1 柵氧化
質量較好的柵氧,其擊穿特性為本征擊穿,通常厚度為10nm的氧化層其擊穿電壓需達到8V以上。
除了熱氧化工藝本身外,氧化前處理也是重要環節。
此處采用SC3 液和HF溶液處理,完成后沖水、甩干,入擴散爐管進行熱氧化,加工條件如表1 所示。氧化完成后,用膜厚儀測試得到膜厚平均值為100 ±3nm,均勻性良好。
3.2 光刻套準
平面型VDMOS N+ 源區、P+ 注入區、歐姆接觸孔等位置在元胞內通常呈中心對稱,如圖1 所示,這是器件電學特性一致性和可靠性的要求。由于自對準工藝采用多晶硅刻蝕后的圖形作為P- 注入掩蔽,其后的N+ 注入掩蔽需要位于多晶硅刻蝕窗口的中心位置,P+ 注入光刻和歐姆接觸孔光刻后形成的窗口也需要位于該區域中心。上述要求除了版圖設計時的精確度量以外,加工過程中的實際套準也至關重要。通常采用數套游標圖形以監控光刻工藝中的套準,本次設計采用第三、四、五圖層游標對套第二層游標的方法,光刻顯影后的實際套準狀況如圖2所示。可見第四次光刻(NLS)與第二次光刻(PLY)套準良好,X 和Y 方向的誤差不超過0.1 μm。第三層與第五層也有類似結果,此處不再一一列出。

圖2 NLS 光刻與PLY光刻套準游標
3.3 多晶硅刻蝕
多晶硅柵自對準工藝要求作為P- 注入掩蔽的多晶硅覆蓋區邊緣光滑、側壁陡直,因此通常采用干法刻蝕工藝形成多晶硅刻蝕窗口,其中刻蝕氣氛、射頻功率、真空度等條件對刻蝕速率、均勻性、各項異性效果影響很大。采用HITACHI M-206 II 設備,首先以一定比例SF6 和CHF3 混合氣體去除多晶硅表面氧化層,然后用Cl2 和HBr 混合氣體刻蝕多晶硅及部分柵氧層。由圖3 可見,采用上述條件刻蝕多晶硅,可以得到接近87°的側壁角度,表面光滑齊整;尤其重要的是,刻蝕完成后的剩余柵氧厚度較為均勻,控制在500 ± 50 μm 的范圍,有利于后續P- 和N+ 注入的均勻性。

圖3 干法刻蝕多晶硅圖片
3.4 P阱推進
導電溝道形成于P 阱表面,該處雜質分布是決定器件閾值電壓的關鍵參數之一,而且,P 阱深度及雜質擴散輪廓與元胞和場限環擊穿電壓密切相關,也是器件抗雪崩擊穿能力的決定性參數。盡管設計良好的器件對于P 阱推結工藝有一定容差,此工序仍應重點監控。采用1150℃,純N2條件下推進330min,得到的結深約6.5 μ m,擴展電阻法測試結果如圖4所示。

圖4 P 阱擴展電阻測試曲線



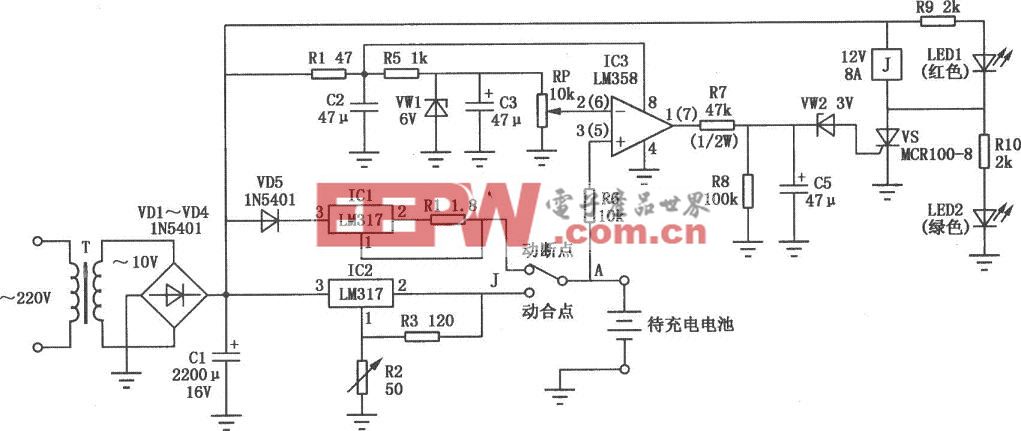



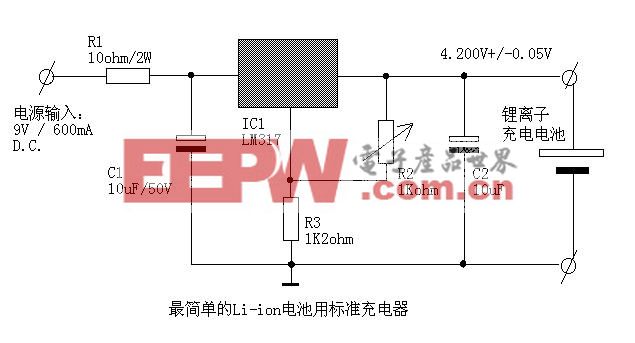
評論