高功率LED開發之CFD模擬散熱解決方案
要計算垂直通過芯片的熱阻,須測量芯片黏合層、芯片墊片、TIM、散熱片以及與基體間的介電層,每階層都各自擁有自己的導熱特性(表2),其中通過芯片,也就是接面到外部環境的熱阻Rja可透過方程式(1)、(2)加以計算:

其中RJ-MS=10 ℃/W
Rja代表熱能由LED芯片傳遞到外界的能力,也就是說,Rja的數值越低、散熱效能越好,圖2分別顯示封裝結構的3D、2D橫切面圖,有助于了解整個散熱路徑。
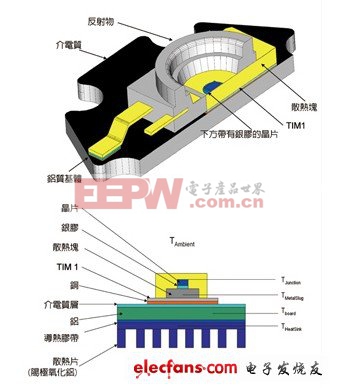
圖2 上圖為LED星狀包裝的3D剖面圖,下圖為帶散熱片LED星狀封裝的2D剖面圖。
進行數值分析/實驗結果分析
安排在MCPCB上的LED封裝通常采用鋁擠方式做為基底,一百一十根鰭片的鰭片型散熱片則透過導熱膠帶黏貼在星形MCPCB背面,封裝以1.2瓦驅動,焊接點的溫度TMetalSlug則透過安排在封裝散熱塊上的熱電偶加以測量(圖3),測量只有在溫度到達穩定時才進行。
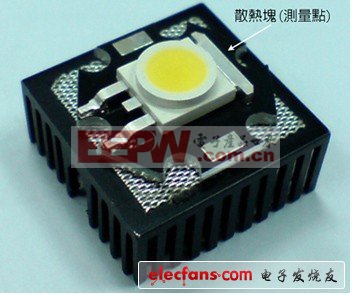
圖3 Moonstone LED封裝上的測量點
表2為仿真模型結果與測量數據的比較,可視化仿真結果分別顯示在圖4,當仿真結果溫度高于測量溫度時,代表數值模型忽略部分的冷卻現象。
表2 仿真結果與測量數據的比較

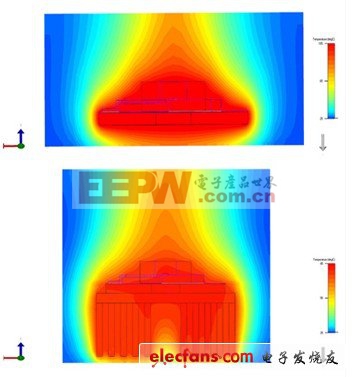
圖4 上圖為LED星形封裝的可視化模擬結果,下圖為詳細散熱片模型的MCPCB LED封裝可視化仿真結果。














評論