柵極導(dǎo)電層Au 遷移導(dǎo)致放大器失效原因分析
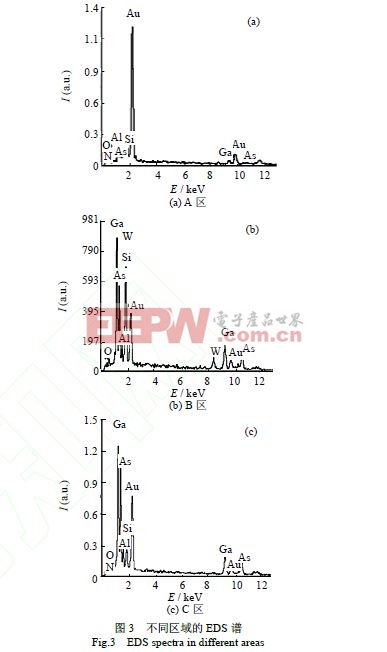

因此,圖3 和表1 的數(shù)據(jù)表明,鍍Au 導(dǎo)電層B區(qū)域出現(xiàn)Au 遷移現(xiàn)象,導(dǎo)致其表面出現(xiàn)孔洞,而一部分的Au 又遷移到C 區(qū)域形成小丘狀的金屬顆粒。
2.2 Au 遷移引起MESFET 管失效原因分析
Au 做肖特基勢(shì)壘金屬時(shí),Au 與GaAs 的黏附性能也不好,并且Au 向半導(dǎo)體內(nèi)部擴(kuò)散及鎵向Au 的擴(kuò)散還促進(jìn)了Au 向砷化鎵擴(kuò)散。而鋁不但具有高的電導(dǎo)率,還與砷化鎵有好的黏附性,但鋁具有易氧化,承受電沖擊的能量較小、易電遷移和電導(dǎo)率比Au 低等特性,因此在鋁和Au 之間加入鎢阻擋層,防止鋁易氧化及屏蔽Au 向GaAs 擴(kuò)散效應(yīng)。
電路工作過(guò)程中,柵條較細(xì),其導(dǎo)電層上面的電流密度較高,金屬離子主要受到電子流對(duì)它的作用力,從而和電子流一樣朝正極方向移動(dòng),相應(yīng)所產(chǎn)生的金屬離子空位向負(fù)極方向移動(dòng),這樣就造成了Au的凈質(zhì)量傳輸。
在電遷移過(guò)程的擴(kuò)展階段,由于采用了高對(duì)流系數(shù)的熱傳導(dǎo)方法,互連結(jié)構(gòu)的實(shí)際溫升得到了控制,顯著減小了高溫引起的原子熱遷移對(duì)電遷移的干擾,所以此階段Au的遷移驅(qū)動(dòng)力主要是電遷移力。
在電遷移過(guò)程的快速失效階段,Au 的遷移是熱遷移和電遷移共同作用的結(jié)果:電遷移力驅(qū)動(dòng)陰極處原子的遷移,Au 的流失導(dǎo)致電阻增大造成了局部區(qū)域的快速溫升;而更高的溫度使得熱遷移力成為原子遷移的主要驅(qū)動(dòng)力,并最終導(dǎo)致了Au 嚴(yán)重的流失,使B 區(qū)域出現(xiàn)孔洞現(xiàn)象,C 區(qū)域出現(xiàn)了含有大量Au 的金屬小丘。
3 結(jié)論
在電流作用下,放大器中MESFET 柵條鍍Au層出現(xiàn)了Au 的電遷移,使導(dǎo)線(xiàn)局部電阻的增大,溫度升高,使 Au 的熱遷移加重,最終導(dǎo)致導(dǎo)線(xiàn)出現(xiàn)孔洞現(xiàn)象和柵源極處出現(xiàn)小丘狀的金屬顆粒。孔洞現(xiàn)象會(huì)使導(dǎo)線(xiàn)出現(xiàn)開(kāi)路,而柵源極間的金屬顆粒造成的不穩(wěn)定接觸會(huì)出現(xiàn)短路現(xiàn)象,導(dǎo)致MESFET 工作參數(shù)漂移和放大器不正常工作。
因此,為了提高抗電遷移能力,設(shè)計(jì)方面應(yīng)從降低電流密度、降低結(jié)溫、增加散熱方面合理研發(fā)半導(dǎo)體器件;工藝方面應(yīng)嚴(yán)格控制金屬膜質(zhì)量并進(jìn)行檢查;最后建議器件在封裝、存儲(chǔ)時(shí)應(yīng)避免濕氣環(huán)境,一定程度上可以降低電遷移的發(fā)生幾率。
電子管相關(guān)文章:電子管原理











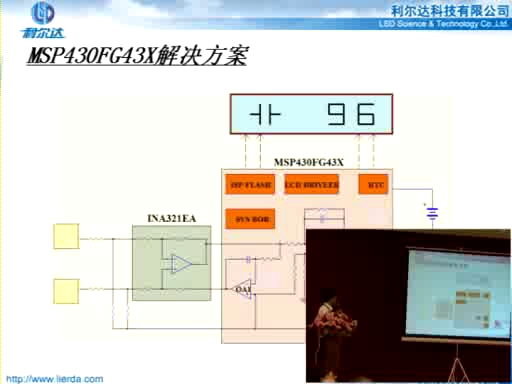

評(píng)論