如何使用氮化鎵器件:引進氮化鎵晶體管技術
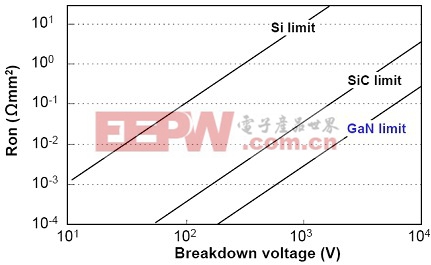
圖一:硅、碳化硅及氮化鎵器件的理論導通電阻與阻擋電壓能力的關系的比較。

圖二:在一個12 V 轉1.2 V的降壓轉換器,氮化鎵場效應晶體管與硅功率MOSFET器件的硬開關開啟速度的比較。 可見三個器件均具備相同導通電阻,但具有不同的擊穿電壓。
氮化鎵器件的橫向結構有助它的flip-chip封裝,它是一種高性能的封裝,因為具最低阻抗及端子電感。此外,氮化鎵功率器件在晶片尺寸方面比硅器件優越,因為它采用高效封裝,使它的尺寸比現今器件小很多。
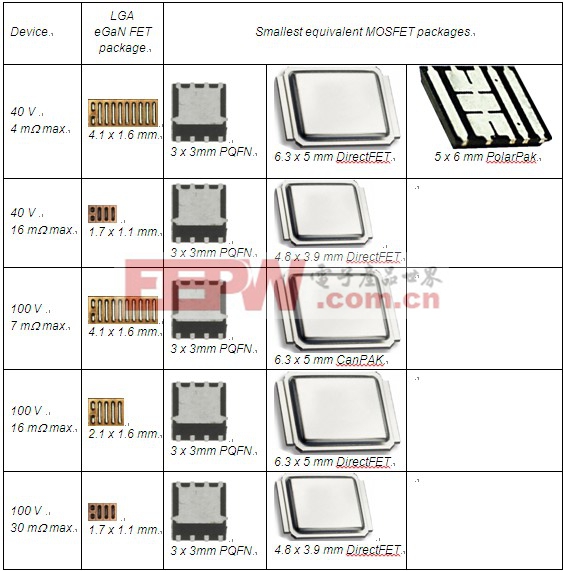
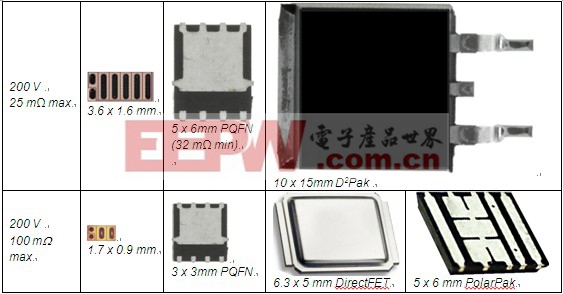
表二:功率MOSFET器件的各種封裝與氮化鎵場效應晶體管的柵格陣列封裝的比較。
表二比較了氮化鎵場效應晶體管與具有相同導通電阻的MOSFET器件的尺寸。氮化鎵場效應晶體管由于具有高效晶片級柵格陣列封裝及更小的晶片尺寸,大大縮小了器件在印刷電路板上的總體占位區域。這證明氮化鎵器件再次比MOSFET器件優勝!
氮化鎵晶體管建構于一個比較新的技術,因而它的制造成本比等效硅器件為高。但這是暫時的情況,正如在我們的教科書(氮化鎵晶體管-高效功率轉換器件)第十四章所述,氮化鎵場效應晶體管可以逾越這個障礙,實現比等效功率MOSFET或IGBT器件更低的成本。
氮化鎵場效應晶體管的基本結構
氮化鎵場效應晶體管的基本結構見圖3。與任何功率場效應晶體管一樣,氮化鎵器件的結構具有柵極、源極和漏極電極。源極和漏極電極穿過AlGaN 頂層與下面的二維電子氣形成歐姆接觸,并在源極和漏極之間形成短路,直至二維電子氣區域內的電子耗盡,以及半絕緣的氮化鎵晶體可以阻隔電流為止。為了耗盡二維電子氣的電子,我們需要將柵極電極放置在AlGaN 層的上面。對于很多早期的氮化鎵晶體管來說,這個柵極電極形成為一個與頂部的表面接觸的肖特基接觸點。在這個接觸點施加負電壓,肖特基勢壘將變成反向偏置,從而使下面的電子耗盡。因此,為了把器件關斷,需要施加相對于漏極和源極電極的負電壓。這種晶體管名為耗盡型或D 型異質結構場效應晶體管(HFET)。
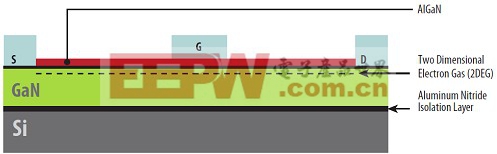
圖三:典型的AlGaN/GaN 異質結構場效應晶體管結構,具柵極、源極和漏極三個金屬半導體接觸點。















評論